
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
ကနဦးကြီးထွားမှုအဆင့်တွင် Temperature Gradient Control ဖြင့် အရည်အသွေးမြင့် SiC Crystal ကြီးထွားမှုကို ရရှိခြင်း
နိဒါန်း
ဆီလီကွန်ကာဗိုက် (SiC) သည် ဗို့အားမြင့်နှင့် အပူချိန်မြင့်သောအသုံးချပရိုဂရမ်များတွင် ထူးခြားသောစွမ်းဆောင်ရည်ကြောင့် မကြာသေးမီနှစ်များအတွင်း သိသိသာသာအာရုံစိုက်မှုရရှိခဲ့သော ကျယ်ပြန့်သော bandgap တစ်ပိုင်းလျှပ်ကူးပစ္စည်းဖြစ်သည်။ Physical Vapor Transport (PVT) နည်းလမ်းများ၏ လျင်မြန်သောတိုးတက်မှုသည် SiC တစ်ခုတည်းသော crystals များ၏ အရည်အသွေးကို မြှင့်တင်ပေးရုံသာမက 150mm SiC တစ်ခုတည်းသော crystals များကိုပါ အောင်မြင်စွာ ပြုလုပ်နိုင်ခဲ့ပါသည်။ သို့သော် အရည်အသွေးSiC wafersအထူးသဖြင့် ချို့ယွင်းချက်သိပ်သည်းဆကို လျှော့ချရေးတွင် နောက်ထပ် မြှင့်တင်မှုများ လိုအပ်နေသေးသည်။ အဓိကအားဖြင့် SiC crystal ကြီးထွားမှုဖြစ်စဉ်အတွင်း ချို့ယွင်းချက်ဖွဲ့စည်းခြင်းယန္တရားများကို မလုံလောက်သောနားလည်မှုဖြင့် ကြီးထွားလာသော SiC ပုံဆောင်ခဲများအတွင်း ချို့ယွင်းချက်အမျိုးမျိုးရှိနေသည်ကို လူသိများသည်။ PVT ကြီးထွားမှု လုပ်ငန်းစဉ်အပေါ် နက်ရှိုင်းစွာ သုတေသနပြုရန် လိုအပ်ပြီး SiC ပုံဆောင်ခဲများ၏ အချင်းနှင့် အလျားကို မြှင့်တင်ပေးကာ SiC-based စက်ပစ္စည်းများ၏ စီးပွားဖြစ်မှုကို အရှိန်မြှင့်ပေးပါသည်။ အရည်အသွေးမြင့် SiC ပုံဆောင်ခဲကြီးထွားမှုကို ရရှိရန်၊ ကျွန်ုပ်တို့သည် ကနဦးကြီးထွားမှုအဆင့်တွင် အပူချိန် gradient ထိန်းချုပ်မှုကို အာရုံစိုက်ခဲ့သည်။ ဆီလီကွန်ကြွယ်ဝသောဓာတ်ငွေ့များ (Si, Si2C) သည် ကနဦးကြီးထွားမှုအဆင့်တွင် မျိုးစေ့ပုံဆောင်ခဲမျက်နှာပြင်ကို ပျက်စီးစေသောကြောင့်၊ ကျွန်ုပ်တို့သည် ကနဦးအဆင့်တွင် မတူညီသော အပူချိန် gradients များကို ဖန်တီးခဲ့ပြီး ပင်မကြီးထွားမှုလုပ်ငန်းစဉ်အတွင်း အဆက်မပြတ် C/Si အချိုးအပူချိန်အခြေအနေများသို့ ချိန်ညှိထားပါသည်။ ဤလေ့လာမှုသည် ပြုပြင်ထားသော လုပ်ငန်းစဉ်အခြေအနေများကို အသုံးပြု၍ စိုက်ပျိုးထားသော SiC ပုံဆောင်ခဲများ၏ လက္ခဏာအမျိုးမျိုးကို စနစ်တကျ စူးစမ်းလေ့လာသည်။
စမ်းသပ်နည်းများ
4° off-axis C-face substrates တွင် PVT နည်းလမ်းကို အသုံးပြု၍ 6 လက်မ 4H-SiC ဘူးသီးများ ကြီးထွားမှုကို လုပ်ဆောင်ခဲ့သည်။ ကနဦးတိုးတက်မှုအဆင့်အတွက် ပိုမိုကောင်းမွန်သော လုပ်ငန်းစဉ်အခြေအနေများကို အဆိုပြုခဲ့သည်။ ကြီးထွားမှုအပူချိန် 2300-2400°C အကြားသတ်မှတ်ထားပြီး နိုက်ထရိုဂျင်နှင့် အာဂွန်ဓာတ်ငွေ့တို့၏ ပတ်ဝန်းကျင်တွင် ဖိအား 5-20 Torr တွင် ထိန်းသိမ်းထားသည်။ ၆လက်မ4H-SiC wafersstandard semiconductor processing techniques များဖြင့် ဖန်တီးထုတ်လုပ်ခဲ့သည်။ ဟိSiC wafersကနဦးကြီးထွားမှုအဆင့်ရှိ မတူညီသော အပူချိန် gradient အခြေအနေများအတိုင်း လုပ်ဆောင်ပြီး ချို့ယွင်းချက်များကို အကဲဖြတ်ရန် 600°C တွင် 14 မိနစ်ကြာ ထွင်းထုထားသည်။ မျက်နှာပြင်၏ etch pit density (EPD) ကို optical microscope (OM) ဖြင့် တိုင်းတာခဲ့သည်။ အမြင့်ဆုံး (FWHM) တန်ဖိုးများတစ်ဝက်ရှိ အကျယ်နှင့် မြေပုံဆွဲပုံများ6 လက်မ SiC wafersResolution မြင့်သော X-ray diffraction (XRD) စနစ်ဖြင့် တိုင်းတာသည်။
ရလဒ်နှင့်ဆွေးနွေးခြင်း

ပုံ 1- SiC Crystal Growth Mechanism ၏ ဇယား
အရည်အသွေးမြင့် SiC တစ်ခုတည်းသော ပုံဆောင်ခဲ ကြီးထွားမှုကို ရရှိရန်၊ ပုံမှန်အားဖြင့် သန့်ရှင်းသော SiC အမှုန့်ရင်းမြစ်များကို အသုံးပြုရန်၊ C/Si အချိုးကို တိကျစွာ ထိန်းချုပ်ရန်နှင့် စဉ်ဆက်မပြတ် ကြီးထွားမှု အပူချိန်နှင့် ဖိအားကို ထိန်းသိမ်းရန် လိုအပ်ပါသည်။ ထို့အပြင်၊ ကနဦးကြီးထွားမှုအဆင့်တွင် အစေ့ပုံဆောင်ခဲများ ဆုံးရှုံးမှုကို လျှော့ချရန်နှင့် အစေ့ပုံဆောင်ခဲပေါ်ရှိ မျက်နှာပြင်ချို့ယွင်းမှုများ ဖြစ်ပေါ်ခြင်းကို နှိမ်နှင်းရန်မှာ အရေးကြီးပါသည်။ ပုံ 1 သည် ဤလေ့လာမှုတွင် SiC ပုံဆောင်ခဲကြီးထွားမှု ယန္တရား၏ ပုံသဏ္ဍာန်ကို သရုပ်ဖော်သည်။ ပုံ 1 တွင်ပြထားသည့်အတိုင်း အခိုးအငွေ့များ (ST) သည် အစေ့၏ပုံဆောင်ခဲမျက်နှာပြင်သို့ သယ်ဆောင်သွားကာ ၎င်းတို့သည် ပျံ့သွားပြီး ပုံဆောင်ခဲဖြစ်လာသည်။ ကြီးထွားမှု (ST) တွင် မပါဝင်သော ဓာတ်ငွေ့အချို့သည် ပုံဆောင်ခဲမျက်နှာပြင်မှ စုပ်ယူသည်။ အစေ့ပုံဆောင်ခဲမျက်နှာပြင် (SG) ပေါ်ရှိ ဓာတ်ငွေ့ပမာဏသည် desorbed gas (SD) ထက်ကျော်လွန်သောအခါ၊ ကြီးထွားမှုလုပ်ငန်းစဉ်သည် ဆက်လက်လုပ်ဆောင်သည်။ ထို့ကြောင့် ကြီးထွားမှုလုပ်ငန်းစဉ်အတွင်း သင့်လျော်သောဓာတ်ငွေ့ (SG)/ဓာတ်ငွေ့ (SD) အချိုးကို RF အပူပေးကွိုင်၏ အနေအထားကို ပြောင်းလဲခြင်းဖြင့် လေ့လာခဲ့သည်။
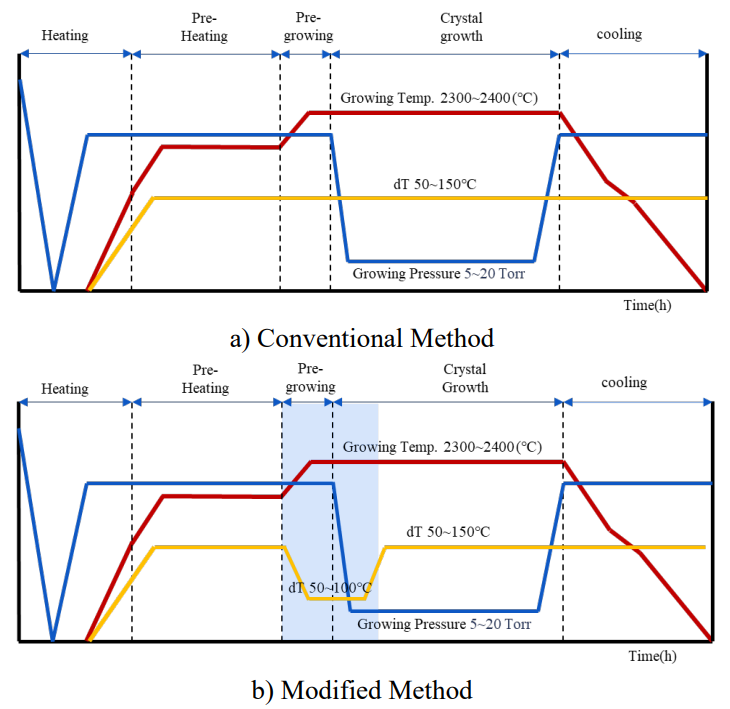
ပုံ 2- SiC Crystal Growth Process Conditions ၏ ဇယား
ပုံ 2 သည် ဤလေ့လာမှုရှိ SiC ပုံဆောင်ခဲကြီးထွားမှုဖြစ်စဉ်အခြေအနေများကို ပုံဖော်ပြသထားသည်။ ပုံမှန်ကြီးထွားမှုလုပ်ငန်းစဉ်အပူချိန်မှာ 2300 မှ 2400°C တွင်ရှိပြီး ဖိအား 5 to 20 Torr တွင် ထိန်းသိမ်းထားသည်။ ကြီးထွားမှုလုပ်ငန်းစဉ်အတွင်း၊ အပူချိန် gradient ကို dT=50~150°C ((က) သမားရိုးကျနည်းလမ်း) တွင် ထိန်းသိမ်းထားသည်။ တစ်ခါတစ်ရံတွင် အရင်းအမြစ်ဓာတ်ငွေ့များ (Si2C၊ SiC2၊ Si) မညီညာသော ထောက်ပံ့မှု မှားယွင်းမှုများ၊ polytype များပါဝင်မှုများနှင့် ပုံဆောင်ခဲအရည်အသွေးကို ကျဆင်းစေနိုင်သည်။ ထို့ကြောင့်၊ ကနဦးကြီးထွားမှုအဆင့်တွင်၊ RF ကွိုင်၏အနေအထားကိုပြောင်းလဲခြင်းဖြင့် dT ကို 50~100°C အတွင်း ဂရုတစိုက်ထိန်းချုပ်ခဲ့ပြီး ပင်မကြီးထွားမှုလုပ်ငန်းစဉ်အတွင်း dT=50~150°C သို့ ချိန်ညှိခဲ့သည် ((ခ) တိုးတက်သောနည်းလမ်း) . အပူချိန် gradient (dT[°C] = Tbottom-Tupper) ကို ထိန်းချုပ်ရန်အတွက် အောက်ခြေအပူချိန်ကို 2300°C တွင် ပုံသေထားပြီး ထိပ်အပူချိန်ကို 2270°C၊ 2250°C၊ 2200°C မှ 2150°C အထိ ချိန်ညှိထားပါသည်။ ဇယား 1 သည် 10 နာရီအကြာတွင် မတူညီသော အပူချိန် gradient အခြေအနေများအောက်တွင် ကြီးထွားလာသော SiC boule မျက်နှာပြင်၏ optical microscope (OM) ပုံများကို တင်ဆက်ထားပါသည်။
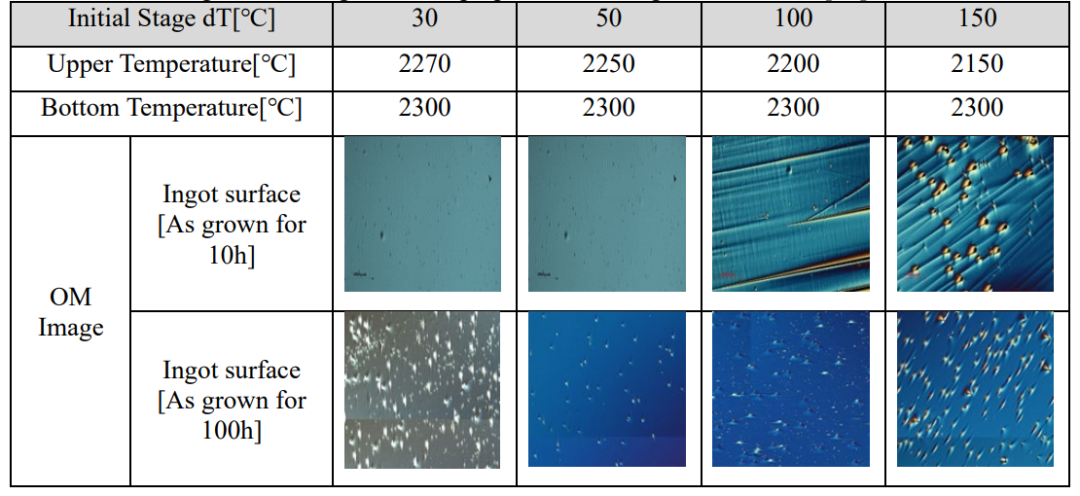
ဇယား 1- Optical Microscope (OM) SiC Boule မျက်နှာပြင်၏ မတူညီသော အပူချိန် မှိန်ဖျော့အခြေအနေများအောက်တွင် 10 နာရီနှင့် 100 နာရီကြာ ကြီးထွားလာပုံများ
ကနဦး dT=50°C တွင်၊ ကြီးထွားမှု 10 နာရီအကြာတွင် SiC boule မျက်နှာပြင်ပေါ်ရှိ ချို့ယွင်းချက်သိပ်သည်းဆသည် dT=30°C နှင့် dT=150°C အောက်တွင် သိသိသာသာနိမ့်သွားသည်။ dT = 30°C တွင်၊ ကနဦး အပူချိန် gradient သည် သေးငယ်လွန်းသဖြင့် အစေ့ပုံဆောင်ခဲများ ဆုံးရှုံးမှုနှင့် ချို့ယွင်းမှုများ ဖြစ်ပေါ်နိုင်သည်။ အပြန်အလှန်အားဖြင့်၊ မြင့်မားသောကနဦးအပူချိန် gradient (dT=150°C) တွင် မတည်မငြိမ် supersaturation အခြေအနေ ဖြစ်ပေါ်နိုင်ပြီး လစ်လပ်နေသော ပြင်းအားများသောကြောင့် polytype များပါဝင်ခြင်းနှင့် ချို့ယွင်းချက်များ ဖြစ်ပေါ်နိုင်သည်။ သို့ရာတွင်၊ ကနဦးအပူချိန် gradient ကို ပိုမိုကောင်းမွန်အောင်ပြုလုပ်ပါက၊ ကနဦးချို့ယွင်းချက်များဖွဲ့စည်းခြင်းကို လျှော့ချခြင်းဖြင့် အရည်အသွေးမြင့် crystal ကြီးထွားမှုကို ရရှိနိုင်သည်။ ကြီးထွားမှု နာရီ 100 ပြီးနောက် SiC ဘူးခွံမျက်နှာပြင်ရှိ ချို့ယွင်းချက်သိပ်သည်းဆသည် 10 နာရီအကြာတွင် ရလဒ်များနှင့် ဆင်တူသောကြောင့်၊ ကနဦးကြီးထွားမှုအဆင့်တွင် ချို့ယွင်းချက်ဖွဲ့စည်းခြင်းကို လျှော့ချခြင်းသည် အရည်အသွေးမြင့် SiC ပုံဆောင်ခဲများရရှိရန် အရေးကြီးသောအဆင့်ဖြစ်သည်။
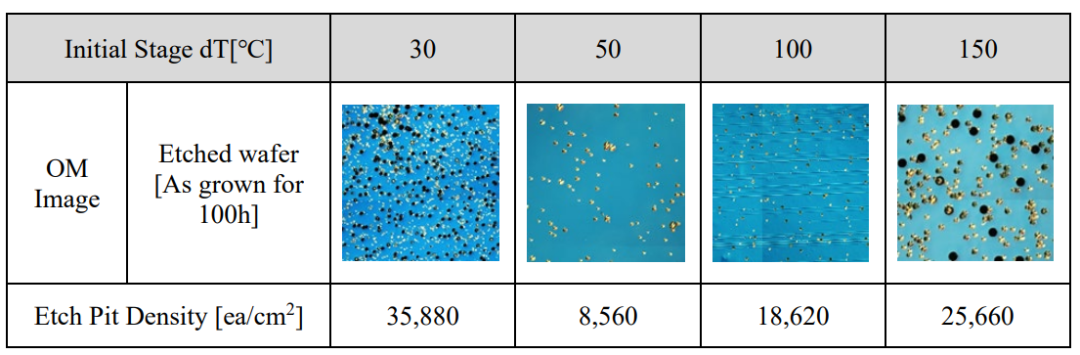
ဇယား 2- မတူညီသော Temperature Gradient Conditions အောက်တွင် Etched SiC Boules များ၏ EPD တန်ဖိုးများ
Wafersဇယား 2 တွင်ပြသထားသည့်အတိုင်း SiC ပုံဆောင်ခဲများ၏ချို့ယွင်းချက်သိပ်သည်းဆကိုလေ့လာရန် နာရီ 100 မှပြင်ဆင်ထားသော ဘူးသီးများမှပြင်ဆင်ထားသော SiC ပုံဆောင်ခဲများ၏ EPD တန်ဖိုးများသည် ကနဦး dT=30°C နှင့် dT=150°C သည် 35,880/cm² နှင့် 25,660 ဖြစ်သည်။ /cm²၊ အသီးသီး၊ SiC ပုံဆောင်ခဲများ၏ EPD တန်ဖိုးသည် အကောင်းဆုံးအခြေအနေများ (dT=50°C) အရ 8,560/cm² သို့ သိသိသာသာ လျော့ကျသွားသည်။
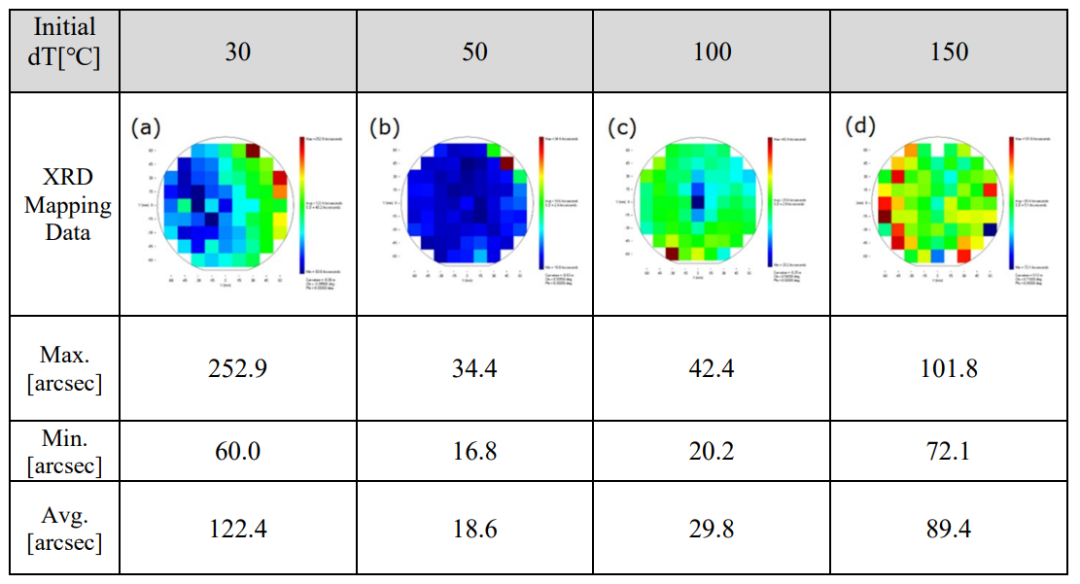
ဇယား 3- FWHM တန်ဖိုးများနှင့် XRD မြေပုံဆွဲခြင်း ကွဲပြားခြားနားသော ကနဦးအပူချိန် အခြေအနေများအောက်တွင် SiC Crystals များ၏ ပုံများ
ဇယား 3 သည် မတူညီသောကနဦးအပူချိန် gradient အခြေအနေများအောက်တွင် ကြီးထွားလာသော SiC crystals များ၏ FWHM တန်ဖိုးများနှင့် XRD မြေပုံထုတ်ပုံများကို ဖော်ပြသည်။ အကောင်းဆုံးအခြေအနေများအောက်တွင် စိုက်ပျိုးထားသော SiC ပုံဆောင်ခဲများ၏ ပျမ်းမျှ FWHM တန်ဖိုးသည် (dT=50°C) သည် 18.6 arcseconds ဖြစ်ပြီး၊ အခြားသော အပူချိန် gradient အခြေအနေများအောက်တွင် စိုက်ပျိုးထားသော SiC crystals များထက် သိသိသာသာနိမ့်ပါသည်။
နိဂုံး
ကွိုင်အနေအထားကိုပြောင်းလဲခြင်းဖြင့် အပူချိန် gradient (dT[°C] = Tbottom-Tupper) ကို ထိန်းချုပ်ခြင်းဖြင့် SiC crystal အရည်အသွေးအပေါ် ကနဦးကြီးထွားမှုအဆင့် အပူချိန် gradient ၏အကျိုးသက်ရောက်မှုကို လေ့လာခဲ့သည်။ ကနဦး dT=50°C အခြေအနေများအောက်တွင် ကြီးထွားပြီးနောက် 10 နာရီကြာပြီးနောက် SiC boule မျက်နှာပြင်ပေါ်ရှိ ချို့ယွင်းချက်သိပ်သည်းဆသည် dT=30°C နှင့် dT=150°C အောက်တွင် သိသာစွာလျော့နည်းကြောင်း ရလဒ်များက ပြသခဲ့သည်။ အကောင်းဆုံးအခြေအနေများအောက်တွင် စိုက်ပျိုးထားသော SiC crystals များ၏ ပျမ်းမျှ FWHM တန်ဖိုးသည် 18.6 arcseconds ဖြစ်ပြီး၊ အခြားအခြေအနေများတွင် စိုက်ပျိုးထားသော SiC crystals များထက် သိသိသာသာနိမ့်ပါသည်။ ၎င်းသည် ကနဦးအပူချိန် gradient ကို ပိုမိုကောင်းမွန်အောင်ပြုလုပ်ခြင်းသည် ကနဦးချို့ယွင်းချက်များဖွဲ့စည်းခြင်းကို ထိရောက်စွာလျှော့ချနိုင်ပြီး အရည်အသွေးမြင့် SiC ပုံဆောင်ခဲကြီးထွားမှုကို ရရှိစေကြောင်း ညွှန်ပြပါသည်။**




