
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Thermal Annealing ဆိုတာဘာလဲ
Thermal Annealing ဟုလည်းသိကြသော annealing process သည် semiconductor ထုတ်လုပ်မှုတွင် အရေးကြီးသော အဆင့်တစ်ခုဖြစ်သည်။ ၎င်းသည် ဆီလီကွန် wafers များကို မြင့်မားသော အပူချိန်တွင် ထားရှိခြင်းဖြင့် ပစ္စည်းများ၏ လျှပ်စစ်နှင့် စက်ပိုင်းဆိုင်ရာ ဂုဏ်သတ္တိများကို မြှင့်တင်ပေးပါသည်။ လိမ်းခြယ်ခြင်း၏ အဓိကပန်းတိုင်များမှာ ရာဇမတ်ကွက်ပျက်စီးမှုကို ပြုပြင်ရန်၊ အညစ်အကြေးများကို အသက်သွင်းရန်၊ ဖလင်ဂုဏ်သတ္တိများကို ပြုပြင်ရန်နှင့် သတ္တုဆီသတ်ဆေးများ ဖန်တီးရန်ဖြစ်သည်။ annealing လုပ်ငန်းစဉ်များတွင် အသုံးပြုလေ့ရှိသော ပစ္စည်းအများအပြားတွင် စိတ်ကြိုက် SiC-coated အစိတ်အပိုင်းများ ပါဝင်သည်။undertaker, အဖုံးများSemicorex မှ ပံ့ပိုးပေးသည်

Annealing လုပ်ငန်းစဉ်၏ အခြေခံမူများ
annealing လုပ်ငန်းစဉ်၏ အခြေခံမူမှာ ပစ္စည်းအတွင်းရှိ အက်တမ်များကို ပြန်လည်စီစဉ်ရန်အတွက် မြင့်မားသောအပူချိန်တွင် အပူစွမ်းအင်ကို အသုံးပြုပြီး တိကျသောရုပ်ပိုင်းဆိုင်ရာနှင့် ဓာတုပြောင်းလဲမှုများကို ရရှိစေပါသည်။ ၎င်းတွင် အဓိကအားဖြင့် အောက်ပါအချက်များ ပါဝင်ပါသည်။
1. ရာဇမတ်ကွက်ပျက်စီးမှုကို ပြုပြင်ခြင်း-
- အိုင်းယွန်းထည့်သွင်းခြင်း- စွမ်းအင်မြင့်မားသော အိုင်းယွန်းများသည် အိုင်းယွန်းထည့်သွင်းစဉ်အတွင်း ဆီလီကွန်ဝေဖာကို ဗုံးကြဲကာ ရာဇမတ်ကွက်ဖွဲ့စည်းပုံကို ထိခိုက်ပျက်စီးစေပြီး အက်စပရပ်ဧရိယာကို ဖန်တီးပေးသည်။
- Annealing ပြုပြင်ခြင်း- မြင့်မားသောအပူချိန်တွင်၊ amorphous ဧရိယာအတွင်းရှိ အက်တမ်များကို ရာဇမတ်ကွက်အစီအစဥ်ကို ပြန်လည်ထိန်းသိမ်းရန် ပြန်လည်စီစဉ်ထားပါသည်။ ဤလုပ်ငန်းစဉ်သည် ပုံမှန်အားဖြင့် အပူချိန် 500°C ခန့် လိုအပ်သည်။
2. ညစ်ညမ်းမှု စတင်ခြင်း-
- Dopant ရွှေ့ပြောင်းခြင်း- ဖြာထွက်သည့် လုပ်ငန်းစဉ်အတွင်း ထိုးသွင်းထားသော အညစ်အကြေးအက်တမ်များသည် ကြားခံနေရာများမှ ကောက်ကွက်များဆီသို့ ရွေ့ပြောင်းကာ ထိရောက်စွာ တားမြစ်ဆေးဖန်တီးပေးသည်။
- အသက်သွင်းခြင်းအပူချိန်- ညစ်ညမ်းမှုအသက်သွင်းခြင်းသည် ပုံမှန်အားဖြင့် 950°C ဝန်းကျင်တွင် ပိုမိုမြင့်မားသောအပူချိန်လိုအပ်သည်။ မြင့်မားသောအပူချိန်များသည် ညစ်ညမ်းမှု၏တက်ကြွမှုနှုန်းကို ပိုမိုဖြစ်ပေါ်စေသော်လည်း မြင့်မားသောအပူချိန်များသည် အလွန်အကျွံညစ်ညမ်းမှုပျံ့နှံ့မှုကို ဖြစ်စေနိုင်ပြီး စက်ပစ္စည်း၏စွမ်းဆောင်ရည်ကို ထိခိုက်စေနိုင်သည်။
3. ရုပ်ရှင်မွမ်းမံမှု-
- Densification - ခြောက်သွေ့သော သို့မဟုတ် စိုစွတ်သော etching တွင် လျော့ရဲသောရုပ်ရှင်များကို အားကောင်းစေပြီး ၎င်းတို့၏ ဂုဏ်သတ္တိများကို ပြောင်းလဲနိုင်သည်။
- High-k gate dielectrics- High-k gate dielectrics များ ကြီးထွားပြီးနောက် Post Deposition Annealing (PDA) သည် dielectric ဂုဏ်သတ္တိများကို မြှင့်တင်ပေးနိုင်သည်၊ gate leakage current ကို လျှော့ချနိုင်ပြီး dielectric ကိန်းသေကို တိုးမြှင့်နိုင်သည်။
4. သတ္တု silicide ဖွဲ့စည်းခြင်း-
- အလွိုင်းအဆင့်- သတ္တုရုပ်ရှင်များ (ဥပမာ၊ ကိုဘော့၊ နီကယ်၊ နှင့် တိုက်တေနီယမ်) သည် သတ္တုစပ်ဖွဲ့စည်းရန်အတွက် ဆီလီကွန်နှင့် ဓာတ်ပြုပါသည်။ မတူညီသော အပူအအေးခံခြင်း အခြေအနေများသည် အမျိုးမျိုးသော အလွိုင်းအဆင့်များ ဖွဲ့စည်းခြင်းကို ဦးတည်စေသည်။
- စွမ်းဆောင်ရည် ပိုမိုကောင်းမွန်အောင်ပြုလုပ်ခြင်း- annealing အပူချိန်နှင့် အချိန်ကို ထိန်းချုပ်ခြင်းဖြင့်၊ ထိတွေ့မှုနည်းပြီး ကိုယ်ထည်ခံနိုင်ရည်ရှိသော အလွိုင်းအဆင့်များကို ရရှိနိုင်ပါသည်။
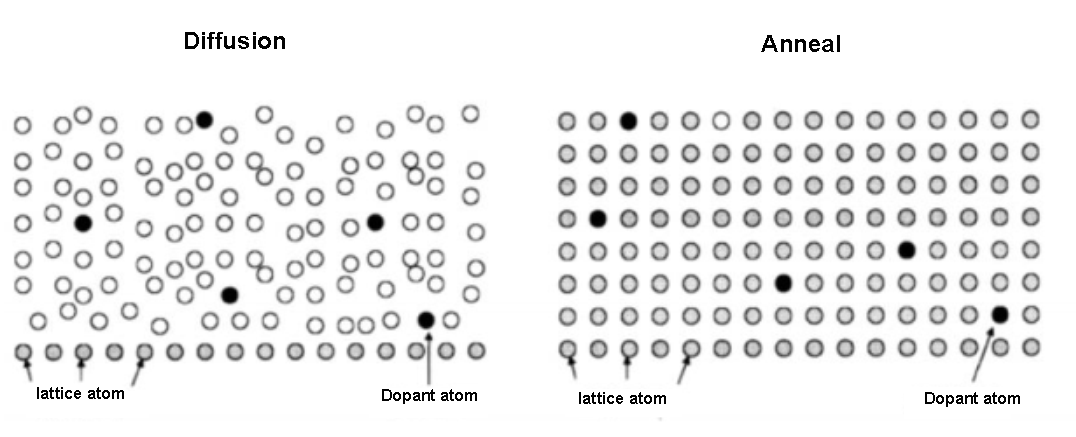
အမျိုးမျိုးသော annealing လုပ်ငန်းစဉ်များ
1. အပူချိန်မြင့် မီးဖိုထဲထည့်ခြင်း-
အင်္ဂါရပ်များ- မြင့်မားသောအပူချိန် (များသောအားဖြင့် 1000°C အထက်) နှင့် ပေါင်းလောင်းချိန် (နာရီပေါင်းများစွာ) ဖြင့် ရိုးရာအလိမ်းလိမ်းနည်း။
အပလီကေးရှင်း- SOI အလွှာပြင်ဆင်မှုနှင့် နက်ရှိုင်းသော n-ကောင်းစွာပျံ့နှံ့မှုကဲ့သို့သော မြင့်မားသောအပူဘတ်ဂျက်လိုအပ်သည့် အက်ပ်များအတွက် သင့်လျော်သည်။
2. လျင်မြန်သော အပူအအေးခံခြင်း (RTA):
အင်္ဂါရပ်များ- လျင်မြန်သော အပူပေးခြင်းနှင့် အအေးပေးခြင်း၏ ဝိသေသလက္ခဏာများကို အသုံးချခြင်းဖြင့်၊ များသောအားဖြင့် အပူချိန် 1000°C နှင့် စက္ကန့်ပိုင်းအတွင်း အချိန်တိုအတွင်း ပြီးမြောက်နိုင်ပါသည်။
လျှောက်လွှာ- အလွန်တိမ်ကောသော လမ်းဆုံများဖွဲ့စည်းခြင်းအတွက် အထူးသင့်လျော်သည်၊ ၎င်းသည် အညစ်အကြေးများ အလွန်အကျွံပျံ့နှံ့မှုကို ထိရောက်စွာ လျှော့ချနိုင်ပြီး အဆင့်မြင့် node ထုတ်လုပ်မှု၏ မရှိမဖြစ်အစိတ်အပိုင်းတစ်ခုဖြစ်သည်။

3. ဖလက်ရှ်မီးခွက် ဖျက်ခြင်း (FLA)-
အင်္ဂါရပ်များ- လျင်မြန်စွာ ဖြာထွက်မှုရရှိရန် အလွန်တိုတောင်းသောအချိန် (မီလီစက္ကန့်များ) အတွင်း ဆီလီကွန်ဝေဖာများ၏ မျက်နှာပြင်ကို အပူပေးရန်အတွက် ပြင်းထန်မှုမြင့်သော ဖလက်ရ်ှမီးချောင်းများကို အသုံးပြုပါ။
အပလီကေးရှင်း- 20nm အောက်တွင် မျဉ်းအကျယ် 20nm အောက်ရှိ လွန်စွာတိမ်ကောနေသော doping activation အတွက် သင့်လျော်သည်၊ ၎င်းသည် မြင့်မားသော impurity activation rate ကို ထိန်းသိမ်းထားစဉ်တွင် ညစ်ညမ်းမှုပျံ့နှံ့မှုကို လျှော့ချပေးနိုင်သည်။

4. Laser Spike Annealing (LSA)-
အင်္ဂါရပ်များ- ဒေသအလိုက်နှင့် တိကျမှုမြင့်မားသော annealing ကိုရရှိရန် အလွန်တိုတောင်းသောအချိန် (microseconds) တွင် ဆီလီကွန်ဝေဖာမျက်နှာပြင်ကို အပူပေးရန်အတွက် လေဆာအလင်းရင်းမြစ်ကို အသုံးပြုပါ။
အပလီကေးရှင်း- FinFET နှင့် high-k/metal gate (HKMG) စက်ပစ္စည်းများထုတ်လုပ်ခြင်းကဲ့သို့သော မြင့်မားသောတိကျမှုထိန်းချုပ်မှုလိုအပ်သော အဆင့်မြင့်လုပ်ငန်းစဉ် node များအတွက် အထူးသင့်လျော်ပါသည်။
Semicorex သည် အရည်အသွေးမြင့်မှုကို ပေးသည်။CVD SiC/TaC အပေါ်ယံပိုင်း အစိတ်အပိုင်းများthermal annealing အတွက်။ သင့်တွင် စုံစမ်းမေးမြန်းမှုများ သို့မဟုတ် နောက်ထပ်အသေးစိတ်အချက်အလက်များ လိုအပ်ပါက၊ ကျွန်ုပ်တို့ထံ ဆက်သွယ်ရန် တုံ့ဆိုင်းမနေပါနှင့်။
ဖုန်း # +86-13567891907 သို့ ဆက်သွယ်နိုင်ပါသည်။
အီးမေးလ်- sales@semicorex.com




