
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
SiGe နှင့် Si Selective Etching နည်းပညာ
FinFET ကို အစားထိုးရန် အဆင်သင့်ဖြစ်နေသော မျိုးဆက်သစ် ထရန်စစ္စတာဗိသုကာလက်ရာတစ်ခုအနေဖြင့် Gate-All-Around FET (GAAFET) သည် သာလွန်ကောင်းမွန်သော electrostatic control နှင့် သေးငယ်သောအတိုင်းအတာများတွင် စွမ်းဆောင်ရည်မြှင့်တင်ပေးနိုင်စွမ်းအတွက် သိသာထင်ရှားသောအာရုံစိုက်မှုကို ရရှိခဲ့သည်။ n-type GAAFET များကို ဖန်တီးရာတွင် အရေးကြီးသော အဆင့်တွင် ရွေးချယ်မှု မြင့်မားခြင်း ပါဝင်သည်။etchingSiGe:Si သည် အတွင်းပိုင်း spacers များမအပ်နှံမီ၊ silicon nano sheets များထုတ်လုပ်ခြင်းနှင့် ချန်နယ်များထုတ်လွှတ်ခြင်းမပြုမီ အစုအဝေးများ။

ဤဆောင်းပါးသည် ရွေးချယ်မှုတွင် ထည့်သွင်းဖော်ပြထားသည်။etching နည်းပညာများဤလုပ်ငန်းစဉ်တွင်ပါဝင်ပြီး SiGe etching တွင် မြင့်မားသောတိကျမှုနှင့် ရွေးချယ်နိုင်မှုရရှိရန်အတွက် ဖြေရှင်းချက်အသစ်များကို ပေးဆောင်သည့် မြင့်မားသောဓာတ်တိုးဓာတ်ငွေ့ပလာစမာ-ကင်းစင်သော etching နှင့် atomic layer etching (ALE) တို့ကို မိတ်ဆက်ပေးပါသည်။
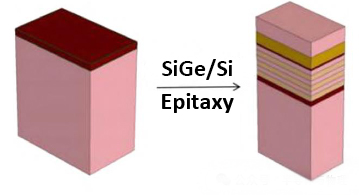
GAA ဖွဲ့စည်းပုံများရှိ SiGe Superlattice အလွှာများ
GAAFETs ၏ ဒီဇိုင်းတွင်၊ စက်စွမ်းဆောင်ရည်ကို မြှင့်တင်ရန်အတွက် Si နှင့် SiGe အလွှာများသည်ဆီလီကွန်အလွှာပေါ်တွင် epitaxially စိုက်ပျိုးသည်။superlattice ဟုလူသိများသော multilayer တည်ဆောက်ပုံ။ ဤ SiGe အလွှာများသည် သယ်ဆောင်သူ၏အာရုံစူးစိုက်မှုကို ချိန်ညှိရုံသာမက စိတ်ဖိစီးမှုကို မိတ်ဆက်ခြင်းဖြင့် အီလက်ထရွန် ရွေ့လျားနိုင်မှုကိုလည်း တိုးတက်စေသည်။ သို့သော်လည်း နောက်ဆက်တွဲ လုပ်ငန်းစဉ်အဆင့်များတွင်၊ ဤ SiGe အလွှာများကို ဆီလီကွန်အလွှာများကို ထိန်းသိမ်းထားစဉ်တွင် တိကျစွာ ဖယ်ရှားရန် လိုအပ်ပြီး ရွေးချယ်ထားသော etching နည်းပညာများ လိုအပ်ပါသည်။
SiGe ၏ Selective Etching အတွက်နည်းလမ်းများ
High Oxidative Gas Plasma-Free Etching
ClF3 ဓာတ်ငွေ့ကို ရွေးချယ်ခြင်း- ဤ etching နည်းလမ်းသည် ClF3 ကဲ့သို့ လွန်ကဲသော ရွေးချယ်နိုင်မှုနှင့်အတူ အလွန်အမင်း oxidative gases ကို အသုံးပြုပြီး SiGe:Si ရွေးချယ်မှုအချိုး 1000-5000 ရရှိသည်။ ၎င်းကို ပလာစမာပျက်စီးမှုမဖြစ်စေဘဲ အခန်းအပူချိန်တွင် ပြီးမြောက်နိုင်သည်။
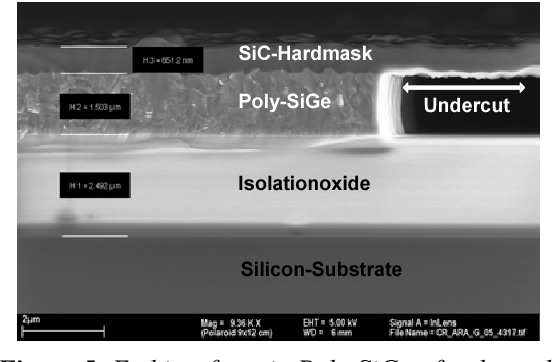
အပူချိန်နိမ့်သော ထိရောက်မှု- အကောင်းဆုံးအပူချိန်မှာ 30°C ဝန်းကျင်ဖြစ်ပြီး၊ အပူချိန်နိမ့်သောအခြေအနေများအောက်တွင် ရွေးချယ်နိုင်မှုမြင့်မားသော etching ကို သတိပြုမိကာ စက်ပစ္စည်းစွမ်းဆောင်ရည်ကို ထိန်းသိမ်းရန်အတွက် အရေးကြီးသော ထပ်လောင်းအပူဘတ်ဂျတ်ကို ရှောင်ရှားရန် လိုအပ်ပါသည်။
ခြောက်သွေ့သောပတ်ဝန်းကျင်- တစ်ခုလုံးetching လုပ်ငန်းစဉ်လုံးဝခြောက်သွေ့သော အခြေအနေအောက်တွင် ပြုလုပ်ထားပြီး ဖွဲ့စည်းတည်ဆောက်ပုံ ကပ်တွယ်မှုအန္တရာယ်ကို ဖယ်ရှားပေးပါသည်။
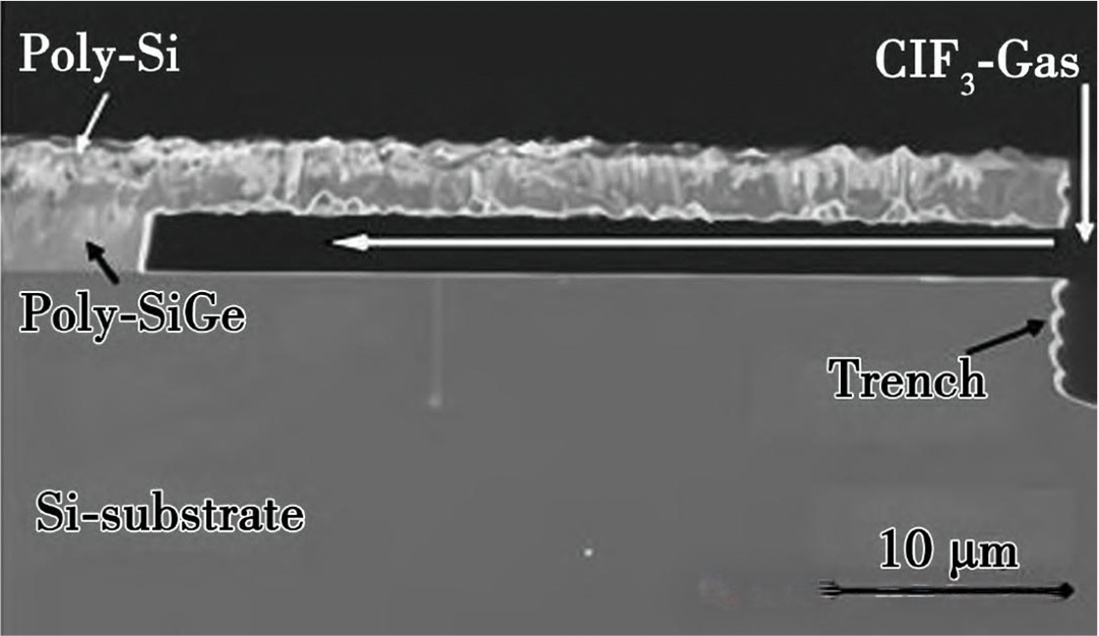
Atomic Layer Etching (ALE)
မိမိကိုယ်ကို ကန့်သတ်ခြင်းလက္ခဏာများ- ALE သည် အဆင့်နှစ်ဆင့် စက်ဘီးစီးမှုဖြစ်သည်။etching နည်းပညာထွင်းထုရမည့်အရာ၏ မျက်နှာပြင်ကို ဦးစွာမွမ်းမံထားရာ၊ ထို့နောက် မွမ်းမံထားသော အစိတ်အပိုင်းများကို မထိခိုက်စေဘဲ ပြုပြင်ထားသော အလွှာကို ဖယ်ရှားသည်။ အဆင့်တစ်ဆင့်ချင်းစီသည် တစ်ကြိမ်လျှင် အဏုမြူအလွှာအနည်းငယ်ကို ဖယ်ရှားသည့်အဆင့်အထိ တိကျသေချာစေရန်အတွက် ကန့်သတ်ချက်ရှိသည်။
Cyclic etching- အထက်ဖော်ပြပါ အဆင့်နှစ်ဆင့်ကို လိုချင်သော etching အတိမ်အနက်ကို အောင်မြင်သည်အထိ ထပ်ခါတလဲလဲ စက်ဘီးစီးထားသည်။ ဤလုပ်ငန်းစဉ်သည် ALE ကိုအောင်မြင်နိုင်စေသည်။အနုမြူအဆင့် တိကျစွာ ထွင်းဖောက်ခြင်းအတွင်းနံရံရှိ သေးငယ်သော အပေါက်များ။

ကျွန်ုပ်တို့သည် Semicorex တွင် အထူးပြုပါသည်။SiC/TaC coated ဂရပ်ဖိုက်ဖြေရှင်းနည်းများတစ်ပိုင်းလျှပ်ကူးပစ္စည်းထုတ်လုပ်ရေးတွင် Etching Processes တွင် အသုံးချသည်၊ သင်သည် စုံစမ်းမေးမြန်းမှုများ သို့မဟုတ် နောက်ထပ်အသေးစိတ်အချက်အလက်များ လိုအပ်ပါက၊ ကျွန်ုပ်တို့ထံ ဆက်သွယ်ရန် တုံ့ဆိုင်းမနေပါနှင့်။
ဆက်သွယ်ရန်ဖုန်း: +86-13567891907
အီးမေးလ်- sales@semicorex.com




