
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Chip ထုတ်လုပ်ခြင်းတွင် SiGe- ပရော်ဖက်ရှင်နယ် သတင်းအစီရင်ခံစာ
Semiconductor Materials များ၏ဆင့်ကဲဖြစ်စဉ်
ခေတ်မီတစ်ပိုင်းလျှပ်ကူးပစ္စည်းနည်းပညာနယ်ပယ်တွင်၊ အသေးစားအလတ်စားပြုလုပ်ခြင်းဆီသို့ မဆုတ်မနစ်မောင်းနှင်မှုသည် ရိုးရာဆီလီကွန်အခြေခံပစ္စည်းများ၏ကန့်သတ်ချက်များကို တွန်းပို့ခဲ့သည်။ မြင့်မားသောစွမ်းဆောင်ရည်နှင့် ပါဝါသုံးစွဲမှုနည်းပါးခြင်းအတွက် လိုအပ်ချက်များကိုဖြည့်ဆည်းရန် SiGe (Silicon Germanium) သည် ၎င်း၏ထူးခြားသောရုပ်ပိုင်းဆိုင်ရာနှင့် လျှပ်စစ်ဂုဏ်သတ္တိများကြောင့် ဆီမီးကွန်ဒတ်တာချစ်ပ်များထုတ်လုပ်ရာတွင် ရွေးချယ်စရာပစ္စည်းတစ်ခုအဖြစ် ပေါ်ထွက်လာခဲ့သည်။ ဤဆောင်းပါးတွင် ပိုင်းခြားဖော်ပြပါသည်။epitaxy လုပ်ငန်းစဉ်SiGe ၏ epitaxial ကြီးထွားမှု၊ တင်းကျပ်သောဆီလီကွန်အပလီကေးရှင်းများနှင့် Gate-All-Around (GAA) ဖွဲ့စည်းပုံများတွင်၎င်း၏အခန်းကဏ္ဍ။
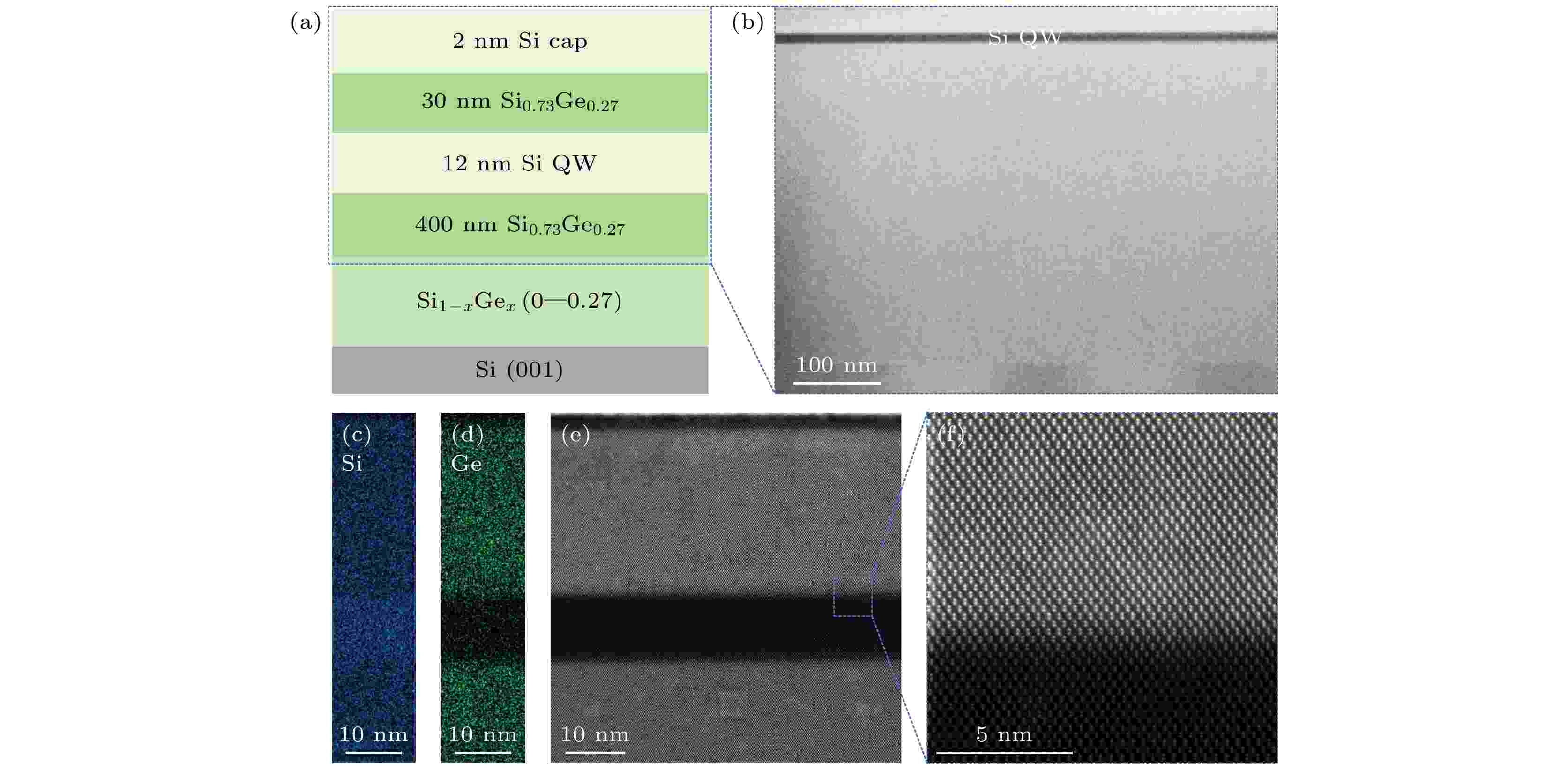
SiGe Epitaxy ၏ထူးခြားချက်
1.1 Chip ထုတ်လုပ်ခြင်းတွင် Epitaxy အား နိဒါန်း-
Epitaxy ဟု အတိုကောက်ခေါ်လေ့ရှိသော Epitaxy သည် တူညီသော ကွက်ကွက်ပုံစံဖြင့် တစ်ခုတည်းသော သလင်းကျောက်အလွှာတစ်ခုပေါ်တွင် ကြီးထွားမှုကို ရည်ညွှန်းသည်။ ဤအလွှာသည်လည်းကောင်း ဖြစ်နိုင်သည်။homoepitaxial (ဥပမာ Si/Si)သို့မဟုတ် heteroepitaxial (ဥပမာ SiGe/Si သို့မဟုတ် SiC/Si)။ Molecular Beam Epitaxy (MBE), Ultra-High Vacuum Chemical Vapor Deposition (UHV/CVD), Atmospheric and Reduced Pressure Epitaxy (ATM & RP Epi) အပါအဝင် epitaxial ကြီးထွားမှုအတွက် နည်းလမ်းအမျိုးမျိုးကို အသုံးပြုသည်။ ဤဆောင်းပါးသည် ဆီလီကွန် (Si) နှင့် ဆီလီကွန်-ဂျာမနီယမ် (SiGe) ၏ epitaxy လုပ်ငန်းစဉ်များကို အလေးပေးဖော်ပြသည် ။
1.2 SiGe Epitaxy ၏ အားသာချက်များ-
အတောအတွင်း ဂျာမနီယမ် (Ge) ၏ အချိုးအစားအချို့ကို ပေါင်းစပ်ခြင်း။epitaxy လုပ်ငန်းစဉ်Bandgap အကျယ်ကို လျှော့ချပေးရုံသာမက transistor ၏ cut-off frequency (fT) ကို တိုးမြင့်စေသည့် SiGe single-crystal အလွှာကို ဖန်တီးပေးသည်။ ၎င်းသည် ကြိုးမဲ့နှင့် optical ဆက်သွယ်မှုများအတွက် ကြိမ်နှုန်းမြင့် စက်များတွင် အကျယ်တဝင့် အသုံးပြုနိုင်စေသည်။ ထို့အပြင်၊ အဆင့်မြင့် CMOS ပေါင်းစည်းထားသော ဆားကစ်လုပ်ငန်းစဉ်များတွင် Ge နှင့် Si အကြား ကွက်လပ်မတူညီမှု (4%) သည် လတ်တင်ပြားဖိစီးမှုကို မိတ်ဆက်ပြီး အီလက်ထရွန်များ သို့မဟုတ် အပေါက်များ၏ ရွေ့လျားနိုင်မှုကို မြှင့်တင်ပေးပြီး စက်ပစ္စည်း၏ ရွှဲရွှဲလျှပ်စီးကြောင်းနှင့် တုံ့ပြန်မှုအမြန်နှုန်းကို တိုးမြှင့်ပေးသည်။
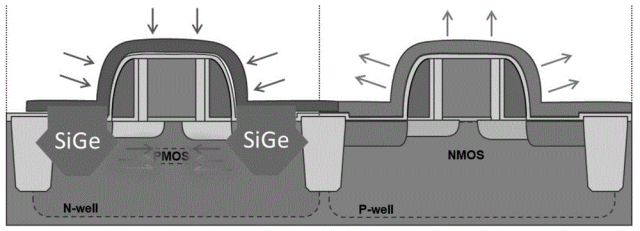
ပြည့်စုံသော SiGe Epitaxy လုပ်ငန်းစဉ်စီးဆင်းမှု
2.1 ကြိုတင်ကုသခြင်း-
ဆီလီကွန် wafers များကို အလိုရှိသော လုပ်ငန်းစဉ်ရလဒ်များပေါ် အခြေခံ၍ ကြိုတင် ကုသထားပြီး၊ အဓိကအားဖြင့် wafer မျက်နှာပြင်ပေါ်ရှိ သဘာဝ အောက်ဆိုဒ် အလွှာနှင့် အညစ်အကြေးများကို ဖယ်ရှားခြင်း ပါဝင်သည်။ ပြင်းထန်စွာဆေးဆိုးထားသော ဆပ်ပြာမှုန့်များအတွက်၊ နောက်ဆက်တွဲကာလအတွင်း အလိုအလျောက်ဆေးဆိုးခြင်းကို လျှော့ချရန် backsealing လိုအပ်ခြင်းရှိမရှိ ထည့်သွင်းစဉ်းစားရန် အရေးကြီးပါသည်။epitaxy ကြီးထွားမှု.
2.2 ကြီးထွားမှုဓာတ်ငွေ့နှင့် အခြေအနေများ-
ဆီလီကွန်ဓာတ်ငွေ့များ- Silane (SiH₄), Dichlorosilane (DCS, SiH₂Cl₂), နှင့် Trichlorosilane (TCS, SiHCl₃) တို့သည် အသုံးအများဆုံး ဆီလီကွန်ဓာတ်ငွေ့ အရင်းအမြစ် သုံးခုဖြစ်သည်။ SiH₄ သည် အပူချိန်နိမ့်သော အပြည့်အဝ epitaxy လုပ်ငန်းစဉ်များအတွက် သင့်လျော်ပြီး ၎င်း၏ လျင်မြန်သော ကြီးထွားနှုန်းအတွက် လူသိများသော TCS ကို အထူပြင်ဆင်မှုအတွက် တွင်ကျယ်စွာ အသုံးပြုပါသည်။ဆီလီကွန် epitaxyအလွှာများ။
ဂျာမီယမ်ဓာတ်ငွေ့- Germane (GeH₄) သည် SiGe သတ္တုစပ်များဖွဲ့စည်းရန် ဆီလီကွန်ရင်းမြစ်များနှင့် တွဲဖက်အသုံးပြုသည့် ဂျာမနီယမ်ကို ပေါင်းထည့်ရန်အတွက် အဓိကအရင်းအမြစ်ဖြစ်သည်။
Selective epitaxy- နှိုင်းရနှုန်းများကို ချိန်ညှိခြင်းဖြင့် ရွေးချယ်ကြီးထွားမှုကို ရရှိသည်။epitaxial အစစ်ခံခြင်း။နှင့် ကလိုရင်းပါဝင်သော ဆီလီကွန်ဓာတ်ငွေ့ DCS ကို အသုံးပြု၍ နေရာတူးခြင်းတွင်၊ ရွေးချယ်နိုင်မှုမှာ ဆီလီကွန်မျက်နှာပြင်ပေါ်ရှိ Cl အက်တမ်များ၏ စုပ်ယူမှုထက် အောက်ဆိုဒ် သို့မဟုတ် နိုက်ထရိုက်များထက် နည်းသောကြောင့် epitaxial ကြီးထွားမှုကို အထောက်အကူဖြစ်စေသည်။ SiH₄ သည် Cl အက်တမ်များ ကင်းမဲ့ပြီး တက်ကြွမှုနည်းသော စွမ်းအင်ဖြင့်၊ ယေဘုယျအားဖြင့် အပူချိန်နိမ့်သော အပြည့်အဝ epitaxy လုပ်ငန်းစဉ်များတွင်သာ အသုံးပြုပါသည်။ နောက်ထပ်အသုံးများသော ဆီလီကွန်ရင်းမြစ်ဖြစ်သည့် TCS သည် အငွေ့ဖိအားနည်းပြီး အခန်းအပူချိန်တွင် အရည်ဖြစ်ပြီး ၎င်းကို တုံ့ပြန်မှုခန်းထဲသို့ မိတ်ဆက်ရန် H₂ bubbling လိုအပ်သည်။ သို့သော်၊ ၎င်းသည် စျေးသိပ်မကြီးသည့်အပြင် ၎င်း၏ လျင်မြန်သော ကြီးထွားနှုန်း (5 μm/min) အထိ ပိုထူသော ဆီလီကွန် epitaxy အလွှာများ ကြီးထွားစေရန်အတွက်၊ ဆီလီကွန် epitaxy wafer ထုတ်လုပ်မှုတွင် တွင်ကျယ်စွာ အသုံးပြုပါသည်။
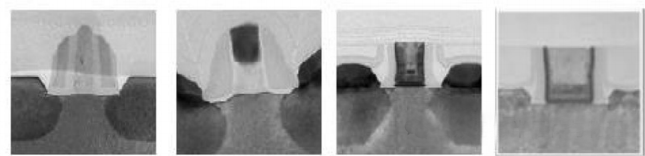
Epitaxial အလွှာများတွင် တင်းမာသော ဆီလီကွန်
ကာလအတွင်းepitaxial ကြီးထွားမှု၊ epitaxial single-crystal Si သည် ဖြေလျှော့ထားသော SiGe အလွှာပေါ်တွင် အပ်နှံထားသည်။ Si နှင့် SiGe အကြား ရာဇမတ်ကွက် မညီမှုကြောင့်၊ Si တစ်ခုတည်းသော သလင်းခဲအလွှာသည် အရင်းခံ SiGe အလွှာမှ ဆွဲဆန့်နိုင်သော ဖိစီးမှုကို ခံရပြီး NMOS ထရန်စစ္စတာများတွင် အီလက်ထရွန် ရွေ့လျားနိုင်မှုကို သိသိသာသာ မြှင့်တင်ပေးပါသည်။ ဤနည်းပညာသည် saturation current (Idsat) ကို တိုးစေရုံသာမက စက်၏ တုံ့ပြန်မှုအမြန်နှုန်းကိုလည်း မြှင့်တင်ပေးပါသည်။ PMOS စက်ပစ္စည်းများအတွက်၊ SiGe အလွှာများသည် ချန်နယ်ပေါ်တွင် ဖိသိပ်ဖိစီးမှုကို မိတ်ဆက်ရန်၊ အပေါက်ရွေ့လျားမှုကို မြှင့်တင်ရန်နှင့် saturation current တိုးလာစေရန် etching ပြီးနောက် အရင်းအမြစ်နှင့် ရေထုတ်သည့်နေရာများတွင် epitaxially ကြီးထွားလာပါသည်။
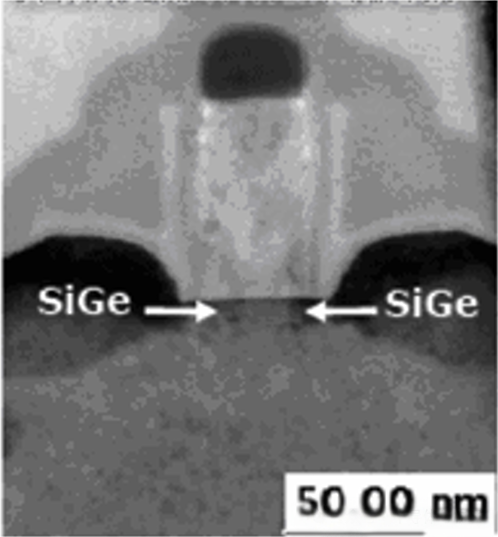
SiGe သည် GAA ဖွဲ့စည်းတည်ဆောက်ပုံများတွင် ယဇ်ပူဇော်ခြင်းအလွှာအဖြစ်
Gate-All-Around (GAA) nanowire ထရန်စစ္စတာများ ထုတ်လုပ်ရာတွင် SiGe အလွှာများသည် ယဇ်ပူဇော်သောအလွှာများအဖြစ် လုပ်ဆောင်သည်။ မြင့်မားသောရွေးချယ်မှု anisotropic etching နည်းပညာများ၊ အက်တမ်တစ်ပိုင်းအလွှာ etching (quasi-ALE) ကဲ့သို့သော SiGe အလွှာများကို တိကျစွာဖယ်ရှားနိုင်စေရန်အတွက် nanowire သို့မဟုတ် nanosheet တည်ဆောက်ပုံများ ဖန်တီးနိုင်စေပါသည်။
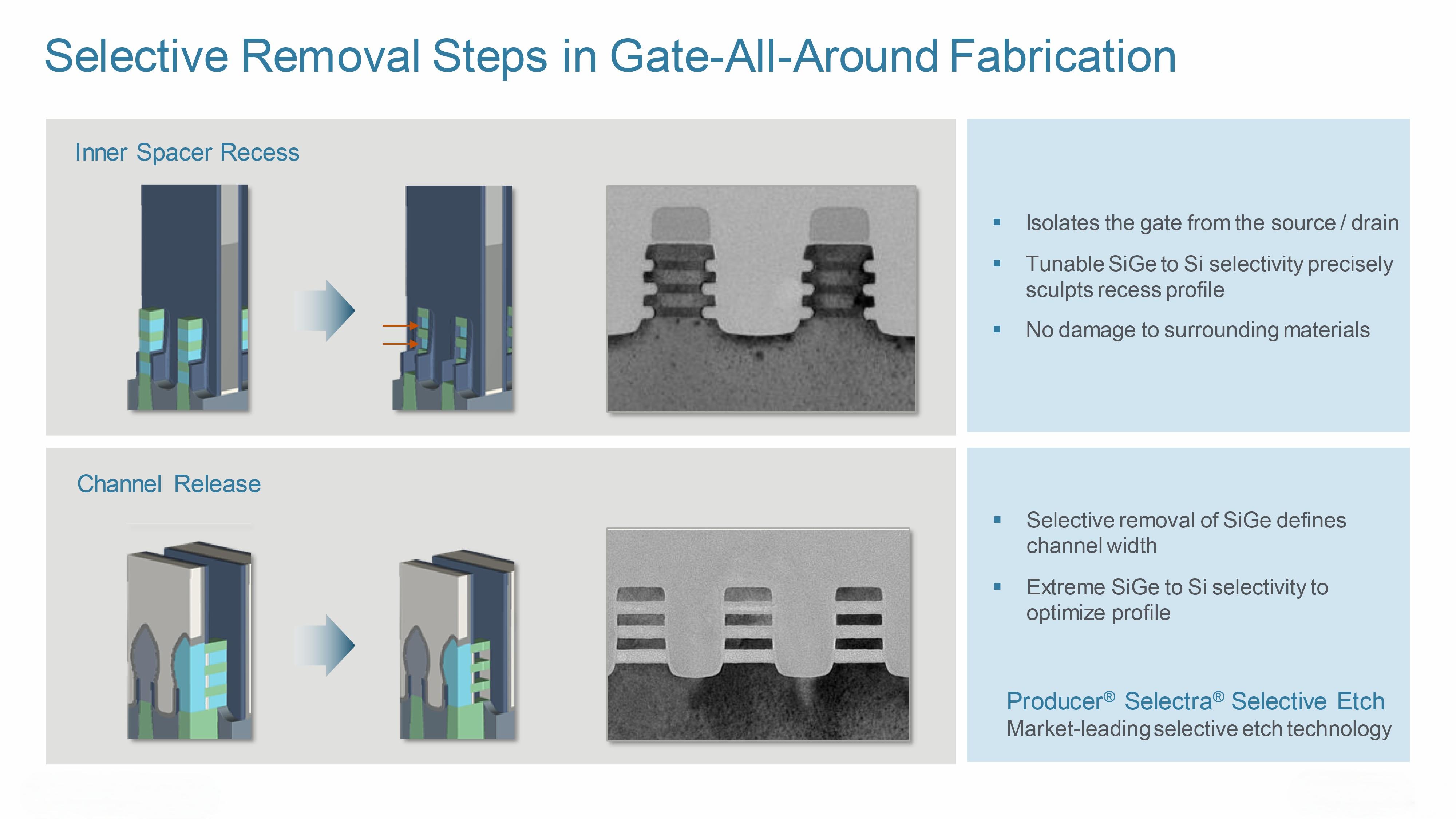
ကျွန်ုပ်တို့သည် Semicorex တွင် အထူးပြုပါသည်။SiC/TaC coated ဂရပ်ဖိုက်ဖြေရှင်းနည်းများတစ်ပိုင်းလျှပ်ကူးပစ္စည်းထုတ်လုပ်မှုတွင် Si epitaxial ကြီးထွားမှုတွင် အသုံးချသည်၊ သင်သည် စုံစမ်းမေးမြန်းမှုများ သို့မဟုတ် နောက်ထပ်အသေးစိတ်အချက်အလက်များကို လိုအပ်ပါက၊ ကျွန်ုပ်တို့ထံ ဆက်သွယ်ရန် တုံ့ဆိုင်းမနေပါနှင့်။
ဆက်သွယ်ရန်ဖုန်း: +86-13567891907
အီးမေးလ်- sales@semicorex.com




