
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
SiC ပုံဆောင်ခဲများတွင် dislocation
SiC substrate တွင် Threading Screw Dislocation (TSD)၊ Threading Edge Dislocation (TED)၊ Base Plane Dislocation (BPD) နှင့် အခြားအရာများကဲ့သို့သော အဏုကြည့်မှန်ချို့ယွင်းချက်များ ရှိနိုင်ပါသည်။ ဤချို့ယွင်းချက်များသည် အက်တမ်အဆင့်ရှိ အက်တမ်များ၏ အစီအစဉ်ကို သွေဖည်ခြင်းကြောင့် ဖြစ်ပေါ်လာခြင်းဖြစ်သည်။
SiC crystals typically grow in a way that extends parallel to the c-axis or at a small angle with it, which means that the c-plane is also known as the base plane. There are two main types of dislocations in the crystal. When the dislocation line is perpendicular to the base plane, the crystal inherits dislocations from the seed crystal into the epitaxial grown crystal. These dislocations are known as penetrating dislocations and can be categorized into threading edge dislocations(TED) and threading screw dislocations(TSD) based on the orientation of the Bernoulli vector to the dislocation line. Dislocations, where both the dislocation lines and the Brönsted vectors are in the base plane, are called base plane dislocations(BPD). SiC crystals can also have composite dislocations, which are a combination of the above dislocations.
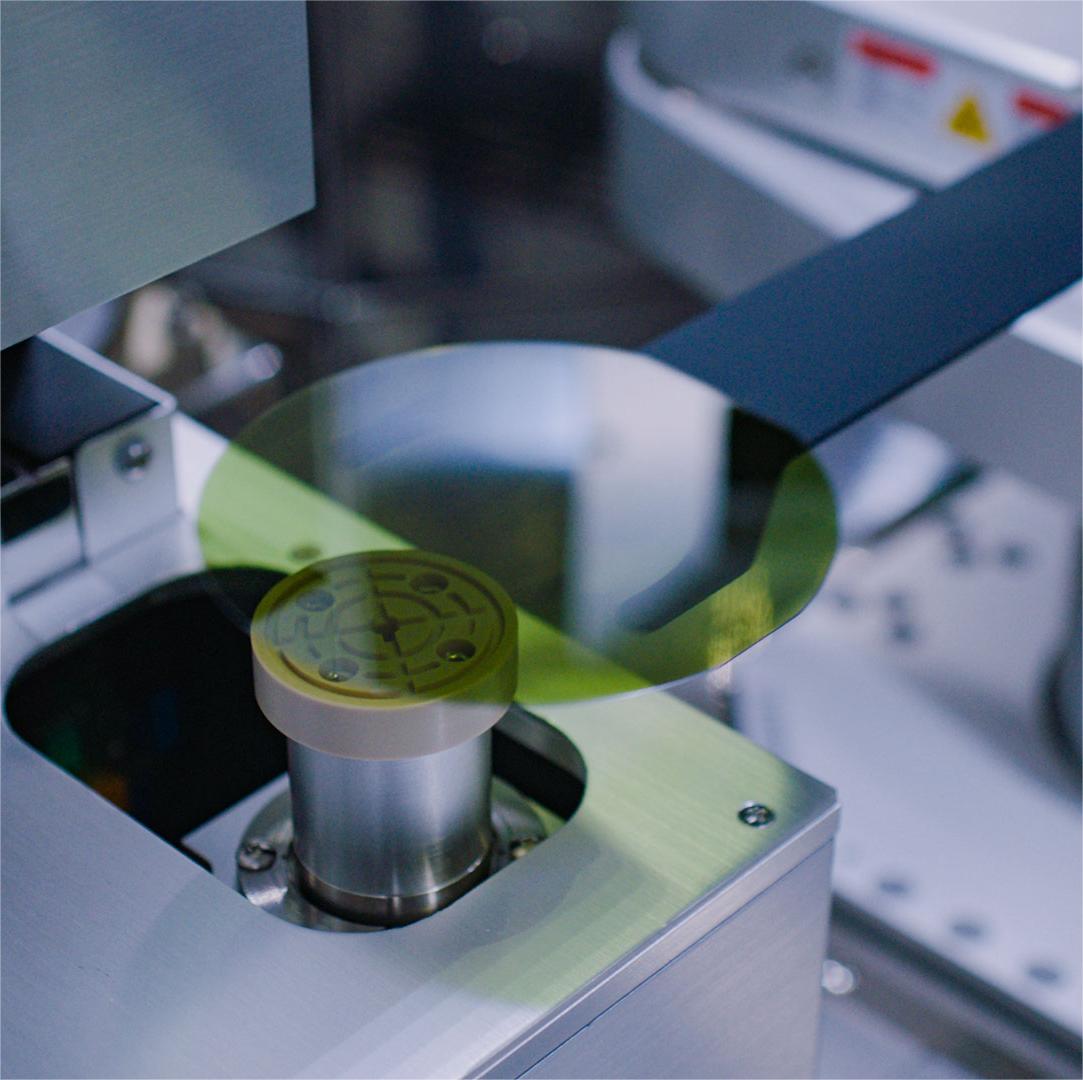
1. TED&TSD
Threaded dislocations (TSDs) နှင့် threaded edge dislocations (TEDs) နှစ်ခုလုံးသည် <0001> နှင့် 1/3<11-20> တို့၏ မတူညီသောဘာဂါ vectors များဖြင့် [0001] ကြီးထွားဝင်ရိုးတစ်လျှောက် လည်ပတ်နေသည်။
TSDs နှင့် TED နှစ်ခုစလုံးသည် အလွှာမှ wafer မျက်နှာပြင်အထိ ချဲ့ထွင်နိုင်ပြီး တွင်းကဲ့သို့ သေးငယ်သော မျက်နှာပြင်အင်္ဂါရပ်များကို ထုတ်လုပ်နိုင်သည်။ ပုံမှန်အားဖြင့် TEDs များ၏ သိပ်သည်းဆသည် 8,000-10,000 1/cm2 ခန့်ဖြစ်ပြီး၊ ၎င်းသည် TSDs များထက် 10 ဆနီးပါးဖြစ်သည်။
SiC epitaxial ကြီးထွားမှုလုပ်ငန်းစဉ်အတွင်း၊ TSD သည် အလွှာမှထပ်တိုးထားသော TSD ၏ epitaxial အလွှာအထိ ချဲ့ထွင်နိုင်ပြီး မြေအောက်မြေလွှာပေါ်ရှိ အခြားချို့ယွင်းချက်များအဖြစ် ပြောင်းလဲနိုင်ပြီး ကြီးထွားဝင်ရိုးတစ်လျှောက်တွင် ပြန့်ပွားနိုင်သည်။
SiC epitaxial ကြီးထွားမှုအတွင်း TSD သည် အလွှာလွှာတွင် အမှားအယွင်းများ (SF) သို့မဟုတ် အလွှာပေါ်ရှိ မုန်လာဥနီချို့ယွင်းချက်များအဖြစ်သို့ ပြောင်းလဲသွားကြောင်း ပြသခဲ့ပြီး၊ epitaxial အလွှာရှိ TED သည် epitaxial ကြီးထွားမှုအတွင်း အလွှာမှအမွေဆက်ခံသော BPD မှ အသွင်ပြောင်းကြောင်းပြသထားသည်။
2. BPD
SiC ပုံဆောင်ခဲများ၏ [0001] တွင်ရှိသော Basal plane dislocations (BPDs) တွင် Burgers vector ၏ 1/3 <11-20> ရှိသည်။
BPDs များသည် SiC wafers များ၏ မျက်နှာပြင်ပေါ်တွင် တွေ့ရခဲသည်။ ၎င်းတို့ကို များသောအားဖြင့် 1500 1/cm2 တွင် သိပ်သည်းဆ 1500 1/cm2 တွင် စုစည်းကြပြီး epitaxial အလွှာရှိ ၎င်းတို့၏သိပ်သည်းဆမှာ 10 1/cm2 ခန့်သာရှိသည်။
SiC အလွှာ၏ထူထပ်လာသည်နှင့်အမျှ BPDs ၏သိပ်သည်းဆသည် လျော့နည်းသွားသည်ကို နားလည်ပါသည်။ photoluminescence (PL) ကိုအသုံးပြု၍ စစ်ဆေးသောအခါ BPD များသည် linear features များကိုပြသသည်။ SiC epitaxial ကြီးထွားမှုလုပ်ငန်းစဉ်အတွင်း၊ တိုးချဲ့ထားသော BPD ကို SF သို့မဟုတ် TED အဖြစ်သို့ ပြောင်းလဲနိုင်သည်။
အထက်ဖော်ပြပါအချက်များအရ SiC အလွှာ wafer တွင် ချို့ယွင်းချက်များ ရှိနေကြောင်း ထင်ရှားပါသည်။ ဤချို့ယွင်းချက်များသည် SiC ကိရိယာကို ဆိုးရွားစွာ ပျက်စီးစေသည့် ပါးလွှာသော ရုပ်ရှင်များ၏ epitaxial ကြီးထွားမှုတွင် အမွေဆက်ခံနိုင်ပါသည်။ ၎င်းသည် မြင့်မားသောပြိုကွဲမှုအကွက်၊ မြင့်မားသောပြောင်းပြန်ဗို့အားနှင့် ယိုစိမ့်လျှပ်စီးကြောင်းများကဲ့သို့သော SiC ၏အားသာချက်များကို ဆုံးရှုံးသွားစေနိုင်သည်။ ထို့အပြင်၊ ၎င်းသည် ထုတ်ကုန်၏ အရည်အသွေးနှုန်းကို လျှော့ချနိုင်ပြီး ယုံကြည်စိတ်ချရမှု လျော့နည်းခြင်းကြောင့် SiC ၏ စက်မှုထွန်းကားရေးတွင် ကြီးမားသော အတားအဆီးများ ဖြစ်စေနိုင်သည်။




