
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
ခေတ်ရေစီးကြောင်း ငြင်းခုံခြင်းနည်းလမ်းများ
တစ်ပိုင်းလျှပ်ကူးပစ္စည်း လုပ်ဆောင်ခြင်း၏ တိုးတက်မှုနှင့် အီလက်ထရွန်နစ် အစိတ်အပိုင်းများအတွက် ဝယ်လိုအား မြင့်တက်လာခြင်းနှင့်အတူ၊ အလွန်ပါးလွှာသော ဝေဖာများ (အထူ 100 မိုက်ခရိုမီတာအောက်) အသုံးချမှုသည် အရေးပါလာပါသည်။ သို့သော်လည်း wafer အထူကို ဆက်လက်လျှော့ချခြင်းဖြင့်၊ ကြိတ်ခွဲခြင်း၊ ထွင်းထုခြင်းနှင့် သတ္တုပြုလုပ်ခြင်းကဲ့သို့သော နောက်ဆက်တွဲလုပ်ငန်းစဉ်များအတွင်း ကွဲအက်ရန် လွန်စွာအန္တရာယ်များပါသည်။
တစ်ပိုင်းလျှပ်ကူးပစ္စည်းကိရိယာများ၏ တည်ငြိမ်သောစွမ်းဆောင်ရည်နှင့် ထုတ်လုပ်မှုအထွက်နှုန်းကို အာမခံရန်အတွက် ယာယီနှောင်ကြိုးနှင့် အဆက်ဖြတ်ခြင်းနည်းပညာများကို ပုံမှန်အားဖြင့် အသုံးပြုပါသည်။ အလွန်ပါးလွှာသော wafer ကို တောင့်တင်းသော ကယ်ရီယာ အလွှာတစ်ခုပေါ်တွင် ယာယီ ပြုပြင်ထားပြီး နောက်ဘက်တွင် လုပ်ဆောင်ပြီးနောက်၊ ၎င်းတို့ နှစ်ခုကို ခွဲခြားထားသည်။ ဤခွဲထုတ်ခြင်းလုပ်ငန်းစဉ်ကို အပူပိုင်းဖြတ်ခြင်း၊ လေဆာ ချေဖျက်ခြင်း၊ ဓာတုပစ္စည်းထုတ်ခြင်း နှင့် စက်ပိုင်းဆိုင်ရာ ချေမှုန်းခြင်း တို့ပါ၀င်သော debonding ဟုခေါ်သည်။
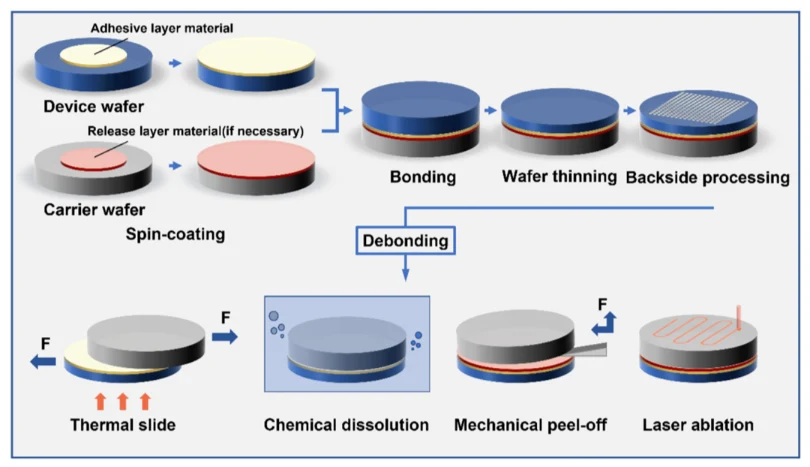
အပူဒဏ်ခံခြင်း။
Thermal debonding သည် အလွန်ပါးလွှာသော wafer များကို carrier substrates များနှင့် ပေါင်းစပ်ထားသော ကော်များကို ပျော့ပျောင်းစေပြီး ပြိုကွဲစေရန် အပူပေးခြင်းဖြင့် ၎င်း၏ ကပ်ငြိမှုကို ဆုံးရှုံးစေသည့် နည်းလမ်းတစ်ခုဖြစ်သည်။ ၎င်းကို အဓိကအားဖြင့် thermal slide debonding နှင့် thermal decomposition debonding ဟူ၍ ပိုင်းခြားထားသည်။
Thermal slide debonding သည် အများအားဖြင့် 190°C မှ 220°C အကြားရှိ ၎င်းတို့၏ပျော့ပြောင်းသည့်အပူချိန်အထိ အပူပေးထားသော wafers များ ပါဝင်ပါသည်။ ဤအပူချိန်တွင်၊ ချည်နှောင်ထားသော ကပ်ခွာသည် ၎င်း၏ ကပ်ငြိမှုကို ဆုံးရှုံးစေပြီး အလွန်ပါးလွှာသော ဆပ်ပြာများကို ကိရိယာများကဲ့သို့သော ကိရိယာများမှ ဖြည်ခြင်းအားဖြင့် ဖြည်းညှင်းစွာ တွန်းထုတ်ခြင်း သို့မဟုတ် အခွံခွာခြင်းများ ပြုလုပ်နိုင်သည်။လေဟာနယ် chucksချောမွေ့စွာခွဲခွာခြင်းအောင်မြင်ရန်။ အပူပြိုကွဲခြင်း ဖယ်ထုတ်ခြင်းတွင်ရှိနေစဉ်၊ ချည်နှောင်ထားသော wafer များသည် ပိုမိုမြင့်မားသောအပူချိန်သို့ အပူပေးကာ ကော်၏ ဓာတုကွဲအက်ခြင်း (မော်လီကျူးကွင်းဆက်ကပ်ခြင်း) ကိုဖြစ်ပေါ်စေပြီး ၎င်း၏ ကပ်ငြိမှုကို လုံးဝဆုံးရှုံးသွားစေသည်။ ရလဒ်အနေဖြင့်၊ ချည်နှောင်ထားသော wafer များကို စက်ပိုင်းဆိုင်ရာ တွန်းအားမပါဘဲ သဘာဝအတိုင်း ခွဲထုတ်နိုင်သည်။
လေဆာဖြတ်ခြင်း
Laser debonding သည် bonded wafers ၏ကော်လွှာပေါ်ရှိလေဆာရောင်ခြည်ဖြာထွက်ခြင်းကိုအသုံးပြုသည့် debonding နည်းလမ်းတစ်ခုဖြစ်သည်။ ကပ်ခွာအလွှာသည် လေဆာစွမ်းအင်ကို စုပ်ယူပြီး အပူကိုထုတ်ပေးကာ photolytic တုံ့ပြန်မှုကို ခံယူသည်။ ဤနည်းလမ်းသည် အလွန်ပါးလွှာသော ဝေဖာများကို အခန်းအပူချိန်တွင် သို့မဟုတ် နိမ့်သောအပူချိန်တွင် သယ်ဆောင်သည့်အလွှာများနှင့် ခွဲထုတ်နိုင်စေပါသည်။
သို့သော်လည်း လေဆာဖယ်ရှားခြင်းအတွက် အရေးကြီးသောကြိုတင်လိုအပ်ချက်မှာ သယ်ဆောင်သူအလွှာသည် အသုံးပြုထားသော လေဆာလှိုင်းအလျားနှင့်အညီ ဖောက်ထွင်းမြင်နိုင်ရမည်ဖြစ်ပါသည်။ ဤနည်းအားဖြင့်၊ လေဆာစွမ်းအင်သည် သယ်ဆောင်ရာအလွှာကို အောင်မြင်စွာ ထိုးဖောက်ဝင်ရောက်နိုင်ပြီး ပေါင်းစပ်အလွှာပစ္စည်းဖြင့် ထိထိရောက်ရောက် စုပ်ယူနိုင်မည်ဖြစ်သည်။ ထို့ကြောင့် လေဆာလှိုင်းအလျားရွေးချယ်မှုသည် အရေးကြီးပါသည်။ ရိုးရိုးလှိုင်းအလျား 248 nm နှင့် 365 nm ပါ၀င်သည်၊ ၎င်းသည် bonding material ၏အလင်းစုပ်ယူမှုလက္ခဏာများနှင့်ကိုက်ညီသင့်သည်။
Chemical Debonding ၊
Chemical debonding သည် သီးခြား chemical solvent ဖြင့် bonding adhesive အလွှာကို ပျော်ဝင်ခြင်းဖြင့် bonded wafers များကို ခွဲထုတ်ခြင်းကို ရရှိသည်။ ဤလုပ်ငန်းစဉ်သည် အလွန်ပါးလွှာသော wafers များနှင့် carrier substrates များကို သဘာဝအတိုင်း ခွဲထုတ်နိုင်စေသည့် ရောင်ရမ်းမှု၊ ကွင်းဆက်ပြတ်တောက်မှုနှင့် နောက်ဆုံးတွင် ပျော်ဝင်မှုဖြစ်စေရန်အတွက် ကော်အလွှာကို ထိုးဖောက်ဝင်ရောက်သည့် ပျော်ရည်မော်လီကျူးများ လိုအပ်သည်။ ထို့ကြောင့်၊ ဖုန်စုပ်စက်များမှ ပံ့ပိုးပေးသော အပိုအပူပေးကိရိယာ သို့မဟုတ် စက်ပိုင်းဆိုင်ရာ တွန်းအား မလိုအပ်ပါ၊ ဓာတုဗေဒနည်းဖြင့် ချေဖျက်ခြင်းသည် wafers ပေါ်တွင် အနည်းငယ်သော ဖိအားကို ထုတ်ပေးပါသည်။
ဤနည်းလမ်းတွင်၊ ဆက်စပ်ပစ္စည်းအလွှာကို အပြည့်အ၀ဆက်သွယ်ပြီး ပျော်ဝင်နိုင်စေရန်အတွက် ကယ်ရီယာဝေဖာများကို မကြာခဏ တူးထားသည်။ ကပ်ခွာအထူသည် ဆားဝင်မှု နှင့် ပျော်ဝင်ခြင်း၏ ထိရောက်မှုနှင့် တူညီမှုကို သက်ရောက်သည်။ ပျော်ဝင်နိုင်သော ချည်နှောင်ထားသော ကော်များသည် အများအားဖြင့် အပူပလတ်စတစ် သို့မဟုတ် ပြုပြင်ထားသော polyimide-based ပစ္စည်းများဖြစ်ပြီး များသောအားဖြင့် spin-coating ဖြင့် အသုံးပြုကြသည်။
Mechanical Debonding
Mechanical debonding သည် အပူ၊ ဓာတုအပျော်ရည်များ သို့မဟုတ် လေဆာရောင်ခြည်များမပါဘဲ ထိန်းချုပ်ထားသော စက်အခွံခွာခြင်းကို အသုံးပြုခြင်းဖြင့် အလွန်ပါးလွှာသော wafers များကို သီးသန့်ခွဲထုတ်သည်။ လုပ်ငန်းစဉ်သည် တိကျသောစက်ပိုင်းဆိုင်ရာလည်ပတ်မှုမှတဆင့် wafer ကို ညင်သာစွာ "ရုတ်သိမ်းသည်" နေရာတွင် တိပ်များကို ဖယ်ရှားခြင်းနှင့် ဆင်တူသည်။
Semicorex သည် အရည်အသွေးမြင့်မှုကို ပေးသည်။SIC Porous Ceramic Debonding Chucks. သင့်တွင် စုံစမ်းမေးမြန်းမှုများ သို့မဟုတ် နောက်ထပ်အသေးစိတ်အချက်အလက်များ လိုအပ်ပါက၊ ကျွန်ုပ်တို့ထံ ဆက်သွယ်ရန် တုံ့ဆိုင်းမနေပါနှင့်။
ဖုန်း # +86-13567891907 သို့ ဆက်သွယ်နိုင်ပါသည်။
အီးမေးလ်- sales@semicorex.com




