
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Semiconductor Heating Elements များအကြောင်း
အပူကုသမှုသည် ဆီမီးကွန်ဒတ်တာ လုပ်ငန်းစဉ်တွင် မရှိမဖြစ် အရေးပါသော လုပ်ငန်းစဉ်များထဲမှ တစ်ခုဖြစ်သည်။ Thermal process သည် oxidation/diffusion/annealing အပါအဝင် သီးခြားဓာတ်ငွေ့များဖြင့် ပြည့်နေသော ပတ်ဝန်းကျင်တစ်ခုတွင် ထားခြင်းဖြင့် wafer သို့ အပူစွမ်းအင်ကို အသုံးချသည့် လုပ်ငန်းစဉ်ဖြစ်သည်။
အပူကုသရေးကိရိယာကို ဓာတ်တိုးခြင်း၊ ပျံ့နှံ့ခြင်း၊ နှိမ့်ချခြင်းနှင့် သတ္တုစပ်ခြင်းလုပ်ငန်းစဉ် လေးမျိုးတွင် အဓိကအားဖြင့် အသုံးပြုပါသည်။
ဓာတ်တိုးခြင်း။အောက်ဆီဂျင် သို့မဟုတ် ရေခိုးရေငွေ့နှင့် အပူချိန်မြင့်မားသော အပူကုသမှုအတွက် အခြားဓာတ်တိုးဆန့်ကျင်ပစ္စည်းများကို လေထုအတွင်း ဆီလီကွန်ဝေဖာတွင် ထားရှိထားပြီး၊ အောက်ဆိုဒ်ဖလင်ဖြစ်စဉ်ကို ဖွဲ့စည်းရန်အတွက် wafer ၏မျက်နှာပြင်ပေါ်ရှိ ဓာတုတုံ့ပြန်မှုသည် အခြေခံလုပ်ငန်းစဉ်၏ ပေါင်းစပ်ပတ်လမ်းလုပ်ငန်းစဉ်တွင် ပိုမိုတွင်ကျယ်စွာအသုံးပြုသည့်တစ်ခုဖြစ်သည်။ Oxidation ရုပ်ရှင်သည် ကျယ်ပြန့်စွာ အသုံးပြုနိုင်ပြီး၊ အိုင်းယွန်းထိုးဆေးနှင့် ထိုးဖောက်ဝင်ရောက်မှုအလွှာ (ပျက်စီးမှုကြားခံအလွှာ)၊ မျက်နှာပြင် passivation၊ insulating gate ပစ္စည်းများ၊ နှင့် device protection layer၊ isolation layer၊ dielectric layer ၏ device structure စသည်တို့အတွက် ပိတ်ဆို့အလွှာအဖြစ် အသုံးပြုနိုင်သည်။
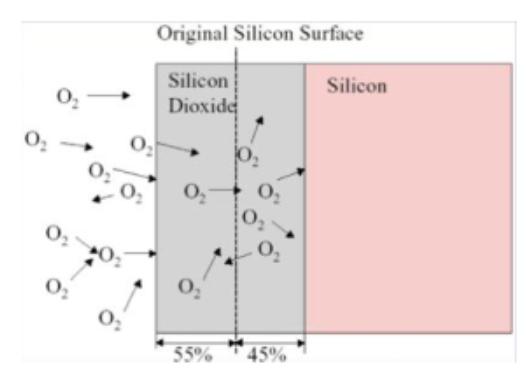
ပျံ့နှံ့ခြင်း။မြင့်မားသောအပူချိန်အခြေအနေတွင်ရှိပြီး၊ လုပ်ငန်းစဉ်လိုအပ်ချက်များနှင့်အညီ ဆီလီကွန်အလွှာထဲသို့ ရောနှောထားသော လုပ်ငန်းစဉ်လိုအပ်ချက်များနှင့်အညီ အပူပျံ့ပျံ့ပွားမှုနိယာမကိုအသုံးပြုခြင်း၊ တိကျသောအာရုံစူးစိုက်မှုဖြန့်ဖြူးခြင်း၊ ပစ္စည်း၏လျှပ်စစ်ဝိသေသလက္ခဏာများကိုပြောင်းလဲရန်၊ ဆီမီးကွန်ဒတ်တာကိရိယာဖွဲ့စည်းပုံဖွဲ့စည်းပုံကိုပြောင်းလဲရန်။ ဆီလီကွန်ပေါင်းစည်းထားသော ဆားကစ်လုပ်ငန်းစဉ်တွင်၊ diffusion လုပ်ငန်းစဉ်ကို ခုခံနိုင်မှု၊ စွမ်းရည်၊ အပြန်အလှန်ချိတ်ဆက်ဝါယာကြိုးများ၊ ဒိုင်အိုဒက်နှင့် ထရန်စစ္စတာများနှင့် အခြားစက်ပစ္စည်းများတွင် ပေါင်းစပ်ဆားကစ်များပြုလုပ်ရန် အသုံးပြုသည်။
Annealthermal annealing၊ integrated circuit process၊ အပူကုသမှုလုပ်ငန်းစဉ်ရှိ နိုက်ထရိုဂျင်နှင့် အခြားမလှုပ်ရှားနိုင်သော လေထုတွင် အားလုံးကို annealing ဟုခေါ်နိုင်သည်၊ ၎င်း၏အခန်းကဏ္ဍမှာ အဓိကအားဖြင့် ရာဇမတ်ကွက်ချို့ယွင်းချက်များကို ဖယ်ရှားရန်နှင့် ဆီလီကွန်ဖွဲ့စည်းပုံရှိ ရာဇမတ်ကွက်များ ပျက်စီးမှုကို ဖယ်ရှားရန်ဖြစ်သည်။
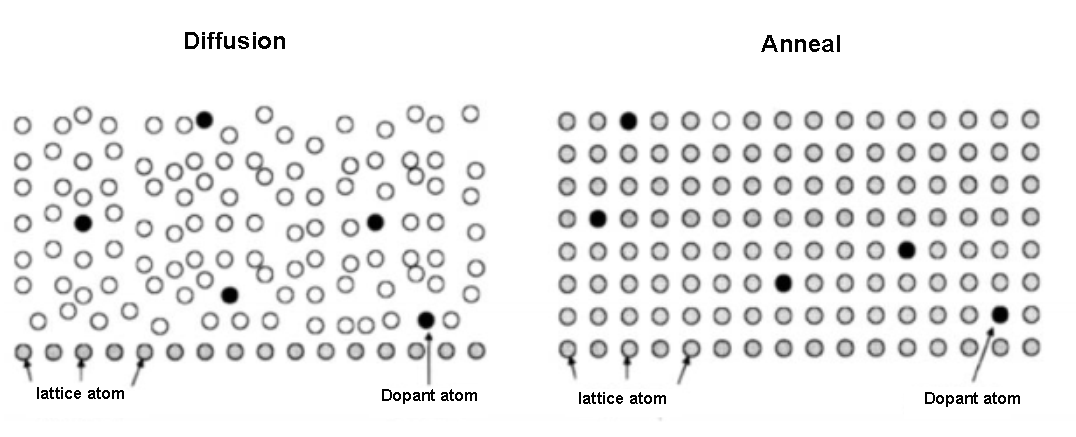
အလွိုင်းသတ္တုများ (Al နှင့် Cu) နှင့် ဆီလီကွန်အလွှာအတွက် ကောင်းမွန်သောအခြေခံအုတ်မြစ်အဖြစ် Cu ဝိုင်ယာကြိုး၏ပုံဆောင်ခဲဖွဲ့စည်းပုံကို တည်ငြိမ်စေရန်နှင့် အညစ်အကြေးများကို ဖယ်ရှားရန်အတွက် အပူချိန်နိမ့်သောအပူကုသမှုသည် ပုံမှန်အားဖြင့် ဆီလီကွန် wafer များကို inert gas သို့မဟုတ် argon လေထုတွင်ထားရှိရန်လိုအပ်ပြီး wiring ၏ယုံကြည်စိတ်ချရမှုကိုတိုးတက်စေသည်။
စက်ပစ္စည်းပုံစံအရ၊ အပူကုသမှုကိရိယာကို ဒေါင်လိုက်မီးဖို၊ အလျားလိုက်မီးဖိုနှင့် လျင်မြန်သောအပူပေးသည့်မီးဖို (Rapid Thermal Processing၊ RTP) ဟူ၍ ခွဲခြားနိုင်သည်။
ဒေါင်လိုက်မီးဖို-ဒေါင်လိုက်မီးဖို၏ အဓိကထိန်းချုပ်မှုစနစ်အား မီးဖိုပြွန်၊ wafer လွှဲပြောင်းစနစ်၊ ဓာတ်ငွေ့ဖြန့်ဖြူးမှုစနစ်၊ အိတ်ဇောစနစ်၊ ထိန်းချုပ်မှုစနစ်ဟူ၍ အပိုင်းငါးပိုင်းခွဲထားသည်။ Furnace tube သည် ဒေါင်လိုက် quartz bellows၊ multi-zone heating resistor wires နှင့် heating tube sleeves များပါ၀င်သော ဆီလီကွန် wafer များကို အပူပေးရာနေရာဖြစ်သည်။ wafer လွှဲပြောင်းမှုစနစ်၏ အဓိကလုပ်ဆောင်ချက်မှာ မီးဖိုပြွန်အတွင်းရှိ wafer များကို သယ်ဆောင်ခြင်းနှင့် ဖယ်ရှားခြင်းဖြစ်ပါသည်။ wafer စားပွဲ၊ မီးဖိုခုံ၊ wafer loading table နှင့် cooling table များအကြား ရွေ့လျားနေသော wafer များကို အလိုအလျောက် စက်ပစ္စည်းများဖြင့် ပြီးမြောက်စေပါသည်။ ဓာတ်ငွေ့ဖြန့်ဖြူးရေးစနစ်သည် မှန်ကန်သောဓာတ်ငွေ့စီးဆင်းမှုကို မီးဖိုပြွန်သို့ လွှဲပြောင်းပေးပြီး မီးဖိုအတွင်းရှိလေထုကို ထိန်းသိမ်းပေးသည်။ အမြီးဓာတ်ငွေ့စနစ်သည် မီးဖိုပြွန်၏ တစ်ဖက်စွန်းရှိ အပေါက်တစ်ခုတွင် တည်ရှိပြီး ဓာတ်ငွေ့နှင့် ၎င်း၏ နောက်ဆက်တွဲရလဒ်များကို လုံးလုံးဖယ်ရှားရန်အတွက် အသုံးပြုသည်။ ထိန်းချုပ်မှုစနစ် (မိုက်ခရိုကွန်ထရိုလာ) သည် လုပ်ငန်းစဉ်အချိန်နှင့် အပူချိန်ထိန်းချုပ်မှု၊ လုပ်ငန်းစဉ်အဆင့်များ၊ ဓာတ်ငွေ့အမျိုးအစား၊ ဓာတ်ငွေ့စီးဆင်းမှုနှုန်း၊ အပူချိန်မြင့်တက်မှုနှင့် ကျဆင်းမှုနှုန်း၊ wafers များကို သယ်ဆောင်ခြင်းနှင့် ဖယ်ရှားခြင်းစသည်ဖြင့် လုပ်ငန်းစဉ်အားလုံးကို ထိန်းချုပ်ပေးပါသည်။ အလျားလိုက်မီးဖိုများနှင့် နှိုင်းယှဉ်ပါက၊ ဒေါင်လိုက်မီးဖိုများသည် ခြေရာခံမှုကို လျော့နည်းစေပြီး ပိုမိုကောင်းမွန်သော အပူချိန်ထိန်းချုပ်မှုနှင့် တူညီမှုကို ခွင့်ပြုပေးပါသည်။
အလျားလိုက် မီးဖို-၎င်း၏ quartz tube သည် ဆီလီကွန် wafer များကို ထားရှိရန်နှင့် အပူပေးရန် အလျားလိုက် ထားရှိထားပါသည်။ ၎င်း၏အဓိကထိန်းချုပ်မှုစနစ်ကို ဒေါင်လိုက်မီးဖိုကဲ့သို့ အပိုင်း ၅ ပိုင်းခွဲထားသည်။
လျင်မြန်သော အပူအအေး စီမံဆောင်ရွက်ပေးသည့် မီးဖို (RTP): Rapid Temperature Rising Furnace (RTP) သည် ဟေလိုဂျင် အနီအောက်ရောင်ခြည် မီးချောင်းများကို အပူရင်းမြစ်အဖြစ် အသုံးပြုသည့် သေးငယ်ပြီး လျင်မြန်သော အပူပေးစနစ်တစ်ခုဖြစ်ပြီး wafer အပူချိန်ကို လုပ်ငန်းစဉ်၏ အပူချိန်သို့ လျင်မြန်စွာ မြှင့်တင်ကာ လုပ်ငန်းစဉ်၏ တည်ငြိမ်စေရန် လိုအပ်သည့်အချိန်ကို လျှော့ချကာ လုပ်ငန်းစဉ်အဆုံးတွင် wafer ကို လျင်မြန်စွာ အအေးပေးပါသည်။ သမားရိုးကျ ဒေါင်လိုက်မီးဖိုများနှင့် နှိုင်းယှဉ်ပါက RTP သည် ၎င်း၏ လျင်မြန်သော အပူပေးအစိတ်အပိုင်းများ၊ အထူး wafer loading ကိရိယာများ၊ အတင်းအကျပ် လေအေးပေးစက်များနှင့် ပိုမိုကောင်းမွန်သော အပူချိန်ထိန်းကိရိယာများဖြစ်သည်။ အထူး wafer loading ကိရိယာသည် wafers များကြားတွင် ပိုမိုတူညီသော အပူပေးခြင်း သို့မဟုတ် အအေးပေးခြင်းတို့ကို ခွင့်ပြုပေးပါသည်။ အထူး wafer loading device သည် wafers များကြားတွင် ပိုမိုတူညီသော အပူပေးခြင်း သို့မဟုတ် အအေးခံနိုင်စေပါသည်။ မီးဖိုတွင်းရှိ လေထုကို ထိန်းချုပ်ခြင်းထက် wafer တစ်လုံးချင်းစီ၏ အပူနှင့် အအေးကို ထိန်းချုပ်နိုင်စေမည့် မော်ဂျူလာအပူချိန် ထိန်းချုပ်မှုများကို အသုံးပြုပါသည်။ ထို့အပြင်၊ wafer ပမာဏ မြင့်မားသော (150-200 wafers) နှင့် ချဉ်းကပ်နှုန်းများကြားတွင် အပေးအယူတစ်ခု ရှိပြီး RTP သည် သေးငယ်သော အစီအစဥ် 1000 မှ wafer နှုန်းသို့ အနည်းငယ်သာ တိုးလာသောကြောင့်၊ တစ်ချိန်တည်းတွင် စီမံဆောင်ရွက်ပြီး ဤသေးငယ်သော အသုတ်အရွယ်အစားသည်လည်း လုပ်ငန်းစဉ်တွင် ပြည်တွင်းလေ၀င်လေထွက်ကို တိုးတက်စေသည်။
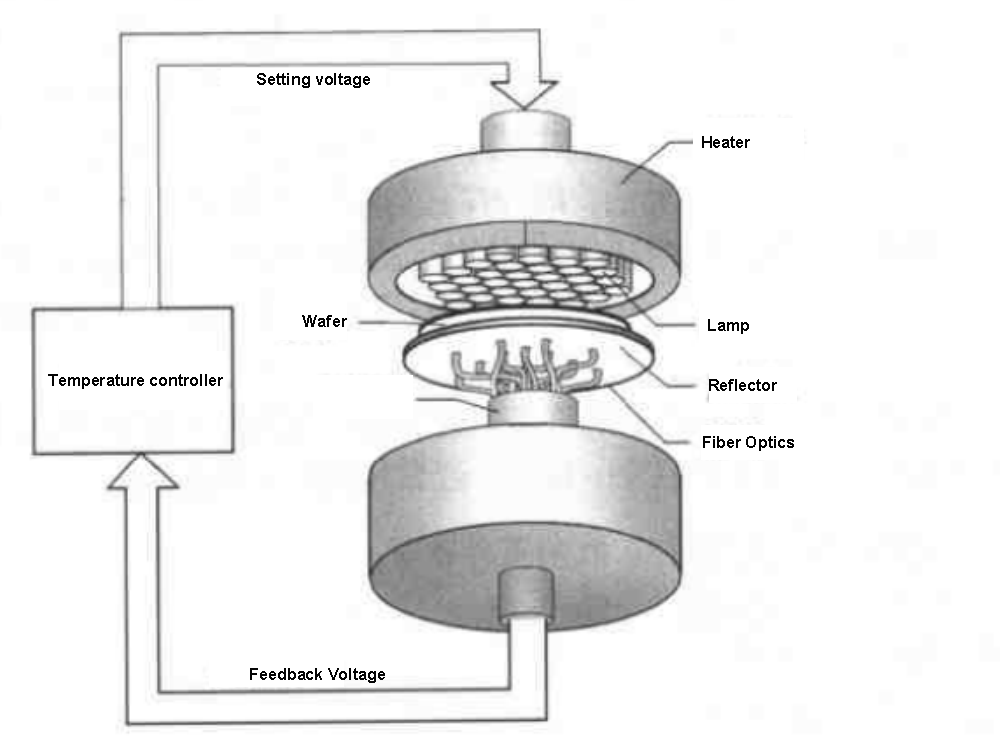
Semicorex သည် အထူးပြုသည်။CVD SiC coatings ဖြင့် SiC အစိတ်အပိုင်းများSemiconductor လုပ်ငန်းစဉ်အတွက်၊ ဥပမာ ပြွန်၊ cantilever paddles၊ wafer boats၊ wafer holder နှင့် စသည်တို့ဖြစ်သည်။ သင့်တွင် မေးခွန်းများ သို့မဟုတ် နောက်ထပ်အချက်အလက်များ လိုအပ်ပါက၊ ကျွန်ုပ်တို့ထံ ဆက်သွယ်နိုင်ပါသည်။
ဆက်သွယ်ရန်ဖုန်း #+၈၆-၁၃၅၆၇၈၉၁၉၀၇
အီးမေးလ်-sales@semicorex.com




