
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
ပြီးပြည့်စုံသော Semiconductor Device Fabrication Process ကို နားလည်ခြင်း။
1. Photolithography
Photolithography သည် ပုံသဏ္ဍာန်မျိုးဆက်နှင့် မကြာခဏ အဓိပ္ပါယ်တူသော တစ်ပိုင်းလျှပ်ကူးတာနည်းပညာ၏ လျင်မြန်သောတိုးတက်မှု၏ နောက်ကွယ်တွင် အရေးပါဆုံးသော မောင်းနှင်အားတစ်ခုဖြစ်ပြီး ပုံနှိပ်ခြင်းတွင် ဓာတ်ပုံပြားပြုလုပ်ခြင်း လုပ်ငန်းစဉ်များမှ အစပြုပါသည်။ ဤနည်းပညာကို အသုံးပြု၍ မိုက်ခရို သို့မဟုတ် နာနိုစကေးပေါ်တွင် မည်သည့်ပုံစံကိုမဆို တင်ပြနိုင်စေပါသည်။ photoresist နှင့် အခြားသော လုပ်ငန်းစဉ်နည်းပညာများနှင့် ပေါင်းစပ်သောအခါ၊ ဤပုံစံများကို ပစ္စည်းများပေါ်သို့ လွှဲပြောင်းပေးကာ ဆီမီးကွန်ဒတ်တာပစ္စည်းများနှင့် စက်ပစ္စည်းများ၏ အမျိုးမျိုးသော ဒီဇိုင်းများနှင့် သဘောတရားများကို သိရှိနားလည်စေသည်။ photolithography တွင်အသုံးပြုသည့်အလင်းရင်းမြစ်သည် ဖော်ပြထားသောပုံစံအတိုင်း ခိုင်မာမှုအဆင့်များတိုးလာခြင်းနှင့် သက်ဆိုင်သည့်ရွေးချယ်စရာများနှင့်အတူ ခရမ်းလွန်ရောင်ခြည်၊ နက်နဲသောခရမ်းလွန်ရောင်ခြည်၊ X-ray နှင့် အီလက်ထရွန်အလင်းတန်းများအထိ ရွေးချယ်စရာများနှင့်အတူ ပုံစံများ၏တိကျမှုကို တိုက်ရိုက်လွှမ်းမိုးပါသည်။
စံပြုဓါတ်ပုံရိုက်နည်း လုပ်ငန်းစဉ်စီးဆင်းမှုတွင် မျက်နှာပြင်ပြင်ဆင်မှု၊ ကပ်တွယ်မှု၊ ပျော့ပျောင်းသောအဖုတ်၊ ထိတွေ့မှု၊ ထိတွေ့မှုလွန်ဖုတ်၊ ဖွံ့ဖြိုးတိုးတက်မှု၊ ခဲဖုတ်နှင့် စစ်ဆေးခြင်းတို့ ပါဝင်သည်။
မျက်နှာပြင် ပြုပြင်ခြင်း သည် အလွှာများ သည် ပုံမှန်အားဖြင့် လေထုမှ H2O မော်လီကျူးများကို စုပ်ယူနိုင်သောကြောင့်၊ ဓါတ်ပုံလိုလစ်သရိုက်ကို ထိခိုက်စေသော အရာဖြစ်သည်။ ထို့ကြောင့်၊ မုန့်ဖုတ်ခြင်းဖြင့် အစပိုင်းတွင် အလွှာများသည် ရေဓာတ်ခန်းခြောက်ခြင်းကို ခံရသည်။
hydrophilic အလွှာအတွက်၊ hydrophobic photoresist တွင် ၎င်းတို့၏ ကပ်တွယ်မှုသည် မလုံလောက်ဘဲ၊ photoresist detachment သို့မဟုတ် pattern misalignment ကို ဖြစ်စေနိုင်သောကြောင့် adhesion မြှင့်တင်ရန် လိုအပ်ပါသည်။ လက်ရှိတွင်၊ hexamethyl disilazane (HMDS) နှင့် tri-methyl-silyl-diethyl-amine (TMSDEA) တို့သည် adhesion enhancers များကို တွင်ကျယ်စွာ အသုံးပြုကြသည်။
မျက်နှာပြင်ကုသမှုပြီးနောက်၊ photoresist ၏အသုံးချမှုကိုစတင်သည်။ အသုံးချ photoresist ၏ အထူသည် ၎င်း၏ viscosity နှင့်သာ သက်ဆိုင်သည်သာမက၊ ယေဘုယျအားဖြင့် spin-coating speed ၏ နှစ်ထပ်ကိန်းနှင့် ပြောင်းပြန်အချိုးကျနေပါသည်။ အဖုံးအုပ်ပြီးနောက်၊ ပျော့ပြောင်းသောအဖုတ်ကို photoresist မှအငွေ့ပျံစေပြီး prebake ဟုခေါ်သော လုပ်ငန်းစဉ်တွင် ကပ်ငြိမှုကို ပိုမိုကောင်းမွန်စေပါသည်။
ဤအဆင့်များပြီးသည်နှင့်၊ ထိတွေ့မှုဖြစ်လာသည်။ Photoresists များကို ထိတွေ့ပြီးနောက် ဆန့်ကျင်ဘက် ဂုဏ်သတ္တိများဖြင့် အပြုသဘော သို့မဟုတ် အနုတ်လက္ခဏာအဖြစ် ခွဲခြားထားသည်။
အပြုသဘောဆောင်သော photoresist ကို နမူနာအဖြစ် ယူပါ၊ ဖော်ထုတ်သူမှ မထိတွေ့သော photoresist သည် developer တွင် မပျော်ဝင်သော်လည်း ထိတွေ့ပြီးနောက် ပျော်ဝင်သွားပါသည်။ ထိတွေ့မှုအတွင်း၊ အလင်းရင်းမြစ်သည် ပုံသဏ္ဍာန်ပြုလုပ်ထားသော မျက်နှာဖုံးကိုဖြတ်သွားကာ၊ ဖုံးအုပ်ထားသော အလွှာကို လင်းထိန်စေပြီး ဓါတ်ခံခုခံမှုကို ပုံသဏ္ဍန်ပြုသည်။ ပုံမှန်အားဖြင့်၊ ထိတွေ့မှုအနေအထားကို တိကျစွာထိန်းချုပ်ရန် မထိတွေ့မီ မျက်နှာဖုံးနှင့် ချိန်ညှိရပါမည်။ ပုံစံပုံပျက်ခြင်းကို ကာကွယ်ရန် အလင်းဝင်သည့်ကြာချိန်ကို တင်းတင်းကျပ်ကျပ် စီမံခန့်ခွဲရပါမည်။ ဤအဆင့်သည် စိတ်ကြိုက်ရွေးချယ်နိုင်ပြီး တိုက်ရိုက်ဖွံ့ဖြိုးတိုးတက်မှုကို ကျော်လွန်နိုင်သော်လည်း ရပ်နေသောလှိုင်းသက်ရောက်မှုများကို လျော့ပါးစေရန် အလင်းဝင်ပြီးနောက်၊ ထပ်လောင်းဖုတ်ရန် လိုအပ်ပါသည်။ ဖွံ့ဖြိုးတိုးတက်မှုသည် ထိတွေ့နေသော photoresist ကို ပျော်ဝင်စေပြီး မျက်နှာဖုံးပုံစံကို photoresist အလွှာပေါ်သို့ တိကျစွာ လွှဲပြောင်းပေးသည်။ ဖွံ့ဖြိုးတိုးတက်မှုအချိန်သည် အရေးကြီးသည်—တိုတောင်းလွန်းပါက မပြည့်စုံသော ဖွံ့ဖြိုးတိုးတက်မှုကို ဖြစ်စေသည်၊ ရှည်လွန်းသောပုံစံကွဲလွဲမှုကို ဖြစ်စေသည်။
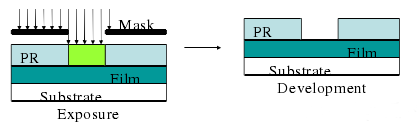
နောက်ပိုင်းတွင်၊ အပြင်းအထန် ဖုတ်ထားသော မုန့်ဖုတ်သည် ဓါတ်တိုးဆန့်ကျင်ဖလင်၏ တွယ်ကပ်မှုကို အားကောင်းစေပြီး ၎င်း၏ etch resistance ကို တိုးတက်စေသည်။ ခဲဖုတ်အပူချိန်သည် ယေဘူယျအားဖြင့် prebake ထက် အနည်းငယ်ပိုမြင့်သည်။
နောက်ဆုံးတွင်၊ အဏုကြည့်မှန်ပြောင်းစစ်ဆေးခြင်းသည် ပုံစံသည် မျှော်လင့်ထားသည်များနှင့် ကိုက်ညီမှုရှိမရှိ စစ်ဆေးသည်။ ပုံစံအား အခြားလုပ်ငန်းစဉ်များဖြင့် ပစ္စည်းပေါ်သို့ လွှဲပြောင်းပြီးနောက်၊ photoresist သည် ၎င်း၏ရည်ရွယ်ချက်ကို ဆောင်ရွက်ခဲ့ပြီး ဖယ်ရှားရမည်ဖြစ်သည်။ ဖယ်ထုတ်ခြင်းနည်းလမ်းများတွင် စိုစွတ်သော (အက်စီတိုကဲ့သို့ ပြင်းထန်သော အော်ဂဲနစ်ပျော်ဝင်ပစ္စည်းများကို အသုံးပြုသည်) နှင့် အခြောက် (ဖလင်ကို ဖယ်ထုတ်ရန်အတွက် အောက်ဆီဂျင်ပလာစမာကို အသုံးပြု၍)။
2. Doping နည်းပညာများ
ဆီမီးကွန်ဒတ်တာနည်းပညာတွင် တားမြစ်ဆေးသည် မရှိမဖြစ်လိုအပ်ပြီး ဆီမီးကွန်ဒတ်တာပစ္စည်းများ၏ လျှပ်စစ်ဂုဏ်သတ္တိများကို လိုအပ်သလို ပြောင်းလဲပေးပါသည်။ အသုံးများသော doping နည်းလမ်းများတွင် thermal diffusion နှင့် ion implantation ပါဝင်သည်။
(၁) Ion Implantation ၊
အိုင်းယွန်းထည့်သွင်းခြင်းသည် စွမ်းအင်မြင့်အိုင်းယွန်းများနှင့် ဗုံးကြဲခြင်းဖြင့် ဆီမီးကွန်ဒတ်တာအလွှာကို ထိခိုက်စေသည်။ thermal diffusion နဲ့ ယှဉ်ရင် အားသာချက်တွေ အများကြီးရှိပါတယ်။ အစုလိုက်အပြုံလိုက်ခွဲခြမ်းစိတ်ဖြာခြင်းဖြင့် ရွေးချယ်ထားသော အိုင်းယွန်းများသည် မြင့်မားသော doping သန့်စင်မှုကို သေချာစေသည်။ စိုက်ပျိုးမှုတစ်လျှောက်လုံး၊ အလွှာသည် အခန်းအပူချိန် သို့မဟုတ် အနည်းငယ်အထက်တွင် ရှိနေသည်။ မျက်နှာဖုံးရုပ်ရှင်အများအပြားကို ဆီလီကွန်ဒိုင်အောက်ဆိုဒ် (SiO2)၊ ဆီလီကွန်နိုက်ထရိတ် (Si3N4) နှင့် photoresist ကဲ့သို့ မြင့်မားသော လိုက်လျောညီထွေရှိသော မျက်နှာဖုံးနည်းပညာများဖြင့် လိုက်လျောညီထွေဖြစ်အောင် အသုံးပြုနိုင်မည်ဖြစ်သည်။ Implant ဆေးများကို တိကျစွာ ထိန်းချုပ်ထားပြီး စိုက်ထားသော အညစ်အကြေး အိုင်းယွန်း ဖြန့်ဖြူးမှုသည် တူညီသော လေယာဉ်အတွင်း တစ်ပြေးညီဖြစ်ပြီး ထပ်တလဲလဲနိုင်မှု မြင့်မားသည်။
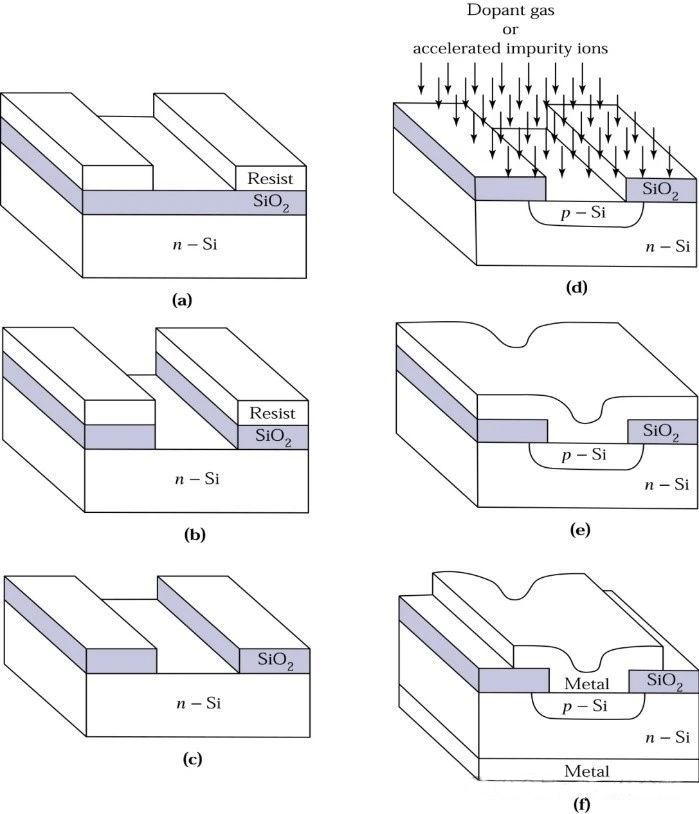
Implantation depth ကို အိုင်းယွန်းများ၏ စွမ်းအင်ဖြင့် ဆုံးဖြတ်သည်။ စွမ်းအင်နှင့် ဆေးပမာဏကို ထိန်းညှိခြင်းဖြင့်၊ အစားထိုးထည့်သွင်းပြီးနောက် အလွှာအတွင်းရှိ အညစ်အကြေးအိုင်းယွန်းများ ဖြန့်ဖြူးမှုကို ခြယ်လှယ်နိုင်သည်။ အမျိုးမျိုးသောညစ်ညမ်းသောပရိုဖိုင်များရရှိရန် အမျိုးမျိုးသောအစီအစဥ်များဖြင့် စိုက်ထည့်ခြင်းများစွာကို စဉ်ဆက်မပြတ်လုပ်ဆောင်နိုင်ပါသည်။ ထူးခြားသည်မှာ၊ တစ်ခုတည်းသော သလင်းကျောက်အလွှာတွင်၊ စိုက်သွင်းခြင်း ဦးတည်ချက်သည် ပုံဆောင်ခဲပုံသဏ္ဍာန် ဦးတည်ချက်နှင့် အပြိုင်ဖြစ်နေပါက၊ လမ်းကြောင်းပြောင်းခြင်းဆိုင်ရာ အကျိုးသက်ရောက်မှုများ ဖြစ်ပေါ်လာသည်—အချို့သော အိုင်းယွန်းများသည် လမ်းကြောင်းတစ်လျှောက် သွားလာနိုင်ပြီး အနက်ပိုင်းကို ထိန်းချုပ်ရန် စိန်ခေါ်မှုဖြစ်စေသည်။
လမ်းကြောင်းပြောင်းခြင်းကို တားဆီးရန်၊ ပုံမှန်အားဖြင့် တစ်ခုတည်းသော သလင်းခဲအလွှာ၏ အဓိကဝင်ရိုးသို့ 7° ထောင့်တွင် အစားထိုးထည့်သွင်းခြင်း သို့မဟုတ် အနုမြူအလွှာကို အနုမြူအလွှာဖြင့် ဖုံးအုပ်ထားခြင်းဖြစ်သည်။
သို့ရာတွင်၊ အိုင်းယွန်းထည့်သွင်းခြင်းသည် အလွှာ၏ပုံဆောင်ခဲဖွဲ့စည်းပုံကို သိသိသာသာ ပျက်စီးစေနိုင်သည်။ စွမ်းအင်မြင့်မားသော အိုင်းယွန်းများ တိုက်မိသည့်အခါတွင်၊ အလွှာ၏ နျူကလိယနှင့် အီလက်ထရွန်များထံသို့ စွမ်းအင်များ လွှဲပြောင်းပေးကာ ၎င်းတို့ကို ရာဇမတ်ကွက်မှ ထွက်ခွာစေပြီး ကြားခံလစ်လပ် ချို့ယွင်းချက်အတွဲများ ဖြစ်ပေါ်လာစေသည်။ ပြင်းထန်သောအခြေအနေများတွင်၊ အချို့သောဒေသများရှိ ပုံဆောင်ခဲဖွဲ့စည်းပုံသည် ပျက်စီးနိုင်ပြီး amorphous zones များဖြစ်လာနိုင်သည်။
ကြမ်းခင်းများ ပျက်စီးခြင်းသည် သယ်ဆောင်သူ၏ ရွေ့လျားနိုင်မှုကို လျှော့ချခြင်း သို့မဟုတ် မျှခြေမညီသော သယ်ဆောင်သူ၏ သက်တမ်းကို လျှော့ချခြင်းကဲ့သို့သော တစ်ပိုင်းလျှပ်ကူးပစ္စည်း၏ လျှပ်စစ်ဂုဏ်သတ္တိများကို ထိခိုက်စေပါသည်။ အရေးအကြီးဆုံးမှာ စိုက်ထားသော အညစ်အကြေးအများစုသည် ထိရောက်သောဆေးဆိုးခြင်းမပြုလုပ်ဘဲ ပုံမှန်မဟုတ်သော ကြားခံနေရာများကို သိမ်းပိုက်ထားသည်။ ထို့ကြောင့် အစားထိုးထည့်သွင်းပြီးနောက် ရာဇမတ်ကွက်များ ပျက်စီးမှုကို ပြုပြင်ခြင်းနှင့် အညစ်အကြေးများကို လျှပ်စစ်ဖြင့် လှုံ့ဆော်ပေးခြင်းသည် မရှိမဖြစ်လိုအပ်ပါသည်။
(၂)လျင်မြန်သောအပူပေးစနစ် (RTP)
Thermal annealing သည် အိုင်းယွန်း စိုက်ခြင်းနှင့် လျှပ်စစ်ဖြင့် အညစ်အကြေးများကို အသက်သွင်းခြင်းကြောင့် ဖြစ်ပေါ်လာသော ရာဇမတ်ကွက်များ ပျက်စီးမှုကို ပြင်ဆင်ရန်အတွက် အထိရောက်ဆုံးနည်းလမ်းဖြစ်သည်။ မြင့်မားသောအပူချိန်တွင်၊ ကြားခံ-လစ်လပ်နေသော ချို့ယွင်းချက်အတွဲများသည် အလွှာ၏ပုံဆောင်ခဲရာဇမတ်ကွက်များ ပြန်လည်ပေါင်းစည်းပြီး ပျောက်ကွယ်သွားလိမ့်မည်၊ amorphous ဒေသများသည် အစိုင်အခဲအဆင့် epitaxy မှတဆင့် တစ်ခုတည်းသော သလင်းခဲဧရိယာများနှင့် နယ်နိမိတ်မှ ပြန်လည်ပုံသွင်းမည်ဖြစ်သည်။ မြင့်မားသောအပူချိန်တွင် အောက်ဆီဂျင်ဓာတ်ပြုခြင်းကို ကာကွယ်ရန်၊ လေဟာနယ် သို့မဟုတ် ပျော့ပျောင်းသောဓာတ်ငွေ့လေထုတွင် အပူအအေးခံခြင်းကို ပြုလုပ်ရပါမည်။ ရိုးရာအလိမ်းလိမ်းခြင်းသည် အချိန်ကြာမြင့်ပြီး ပျံ့နှံ့မှုကြောင့် သိသာထင်ရှားသော အညစ်အကြေးပြန်လည်ဖြန့်ဖြူးမှုကို ဖြစ်စေနိုင်သည်။
ထွန်းကား၏။RTP နည်းပညာတိုတောင်းသော annealing ကြာချိန်အတွင်း ရာဇမတ်ကွက်များ ပျက်စီးခြင်းနှင့် ညစ်ညမ်းမှုအသက်သွင်းခြင်းတို့ကို ပြီးမြောက်စေပါသည်။
အပူအရင်းအမြစ်ပေါ်မူတည်ပြီး၊RTPအီလက်ထရွန်ရောင်ခြည်စကင်န်ဖတ်ခြင်း၊ ခုန်နေသောအီလက်ထရွန်နှင့်အိုင်းယွန်းအလင်းတန်းများ၊ ခုန်နှုန်းလေဆာများ၊ အဆက်မပြတ်လှိုင်းလေဆာများ၊ နှင့် ဘရော့ဘန်းမညီသောအလင်းရင်းမြစ်များ (ဟာလိုဂျင်မီးအိမ်များ၊ ဂရပ်ဖိုက်အပူပေးစက်များ၊ အာခီမီးချောင်းများ)၊ နောက်ပိုင်းတွင် အသုံးအများဆုံးဖြစ်သည်။ ဤရင်းမြစ်များသည် အလွှာကို လိုအပ်သော အပူချိန်သို့ တခဏချင်း အပူပေးကာ အချိန်တိုအတွင်း စိမ့်ဝင်မှု ပြီးမြောက်ကာ အညစ်အကြေး ပျံ့နှံ့မှုကို ထိရောက်စွာ လျှော့ချပေးနိုင်ပါသည်။
3. Film Deposition နည်းပညာများ
(၁) Plasma-Enhanced Chemical Vapor Deposition (PECVD)
PECVD သည် ဓာတုအငွေ့များ စွန့်ပစ်ခြင်း (CVD) နည်းပညာ၏ ပုံစံတစ်ခုဖြစ်ပြီး ကျန်နှစ်ခုမှာ Atmospheric Pressure CVD (APCVD) နှင့် Low Pressure CVD (LPCVD) တို့ဖြစ်သည်။
လက်ရှိတွင် PECVD သည် အမျိုးအစားသုံးမျိုးတွင် အသုံးအများဆုံးဖြစ်သည်။ ၎င်းသည် အပူချိန်နိမ့်သော အပူချိန်တွင် ဓာတုတုံ့ပြန်မှုများကို စတင်ရန်နှင့် ထိန်းထားရန် ရေဒီယိုကြိမ်နှုန်း (RF) ပလာစမာကို အသုံးပြုထားသောကြောင့် အပူချိန်နိမ့်သော ဖလင်များကို စုဆောင်းမှုနှုန်းမြင့်မားစွာဖြင့် လွယ်ကူချောမွေ့စေသည်။ ၎င်း၏ စက်ကိရိယာပုံသဏ္ဍာန်သည် ပုံတွင်ပြထားသည့်အတိုင်းဖြစ်သည်။
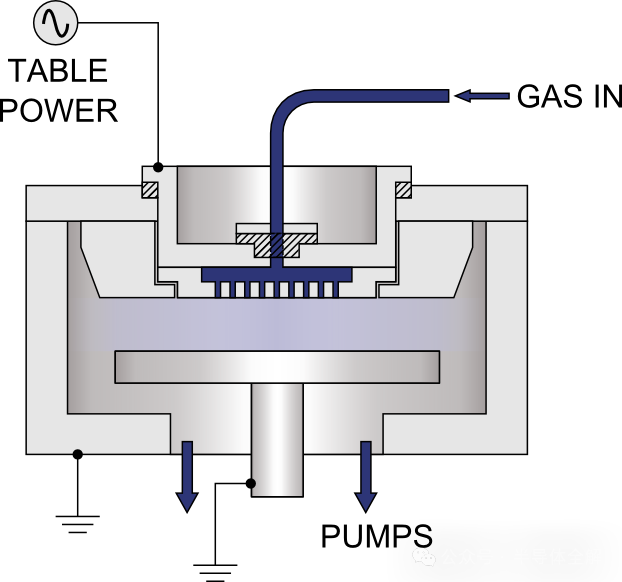
ဤနည်းလမ်းဖြင့် ထုတ်လုပ်ထားသော ရုပ်ရှင်များသည် ထူးထူးခြားခြား ကပ်တွယ်မှုနှင့် လျှပ်စစ်ဂုဏ်သတ္တိများ၊ သေးငယ်သော သေးငယ်သော ဖောက်ပြန်မှု၊ မြင့်မားသော တူညီမှုနှင့် ခိုင်ခံ့သော သေးငယ်သော ဖြည့်စွက်စွမ်းရည်များကို ပြသထားသည်။ PECVD စုဆောင်းခြင်း၏ အရည်အသွေးကို ထိခိုက်စေသည့် အကြောင်းရင်းများတွင် အလွှာအပူချိန်၊ ဓာတ်ငွေ့စီးဆင်းမှုနှုန်း၊ ဖိအား၊ RF ပါဝါနှင့် ကြိမ်နှုန်းတို့ ပါဝင်သည်။
(၂) ရေပက်ခြင်း။
Sputtering သည် Physical Vapor Deposition (PVD) နည်းလမ်းဖြစ်သည်။ အားသွင်းထားသော အိုင်းယွန်းများ (အများအားဖြင့် အာဂွန်အိုင်းယွန်း၊ Ar+) သည် လျှပ်စစ်စက်ကွင်းတွင် အရှိန်မြှင့်ကာ အရွေ့စွမ်းအင်ကို ရရှိသည်။ ၎င်းတို့သည် ပစ်မှတ်ပစ္စည်းဆီသို့ ဦးတည်သွားကာ ပစ်မှတ်မော်လီကျူးများနှင့် တိုက်မိကာ ၎င်းတို့ကို လွင့်ထွက်စေပြီး လွင့်ထွက်သွားစေသည်။ ဤမော်လီကျူးများသည် သိသာထင်ရှားသော အရွေ့စွမ်းအင်များပါ၀င်ပြီး ၎င်းအပေါ်၌ စုပုံနေသော အလွှာဆီသို့ ရွေ့လျားသည်။

ပုံမှန်အားဖြင့် အသုံးပြုသော sputtering ပါဝါရင်းမြစ်များတွင် Direct Current (DC) နှင့် Radio Frequency (RF) တို့ ပါဝင်ပြီး DC sputtering သည် သတ္တုများကဲ့သို့ လျှပ်ကူးပစ္စည်းနှင့် တိုက်ရိုက်သက်ဆိုင်ပြီး insulating materials များတွင် RF sputtering လိုအပ်ပါသည်။
သမားရိုးကျ sputtering သည် စုဆောင်းမှုနှုန်းနိမ့်ကျပြီး အလုပ်ဖိအားများခြင်းကြောင့် ခံစားရပြီး ဖလင်အရည်အသွေး နိမ့်ကျစေသည်။ Magnetron sputtering သည် ဤပြဿနာများကို ပိုမို ကောင်းမွန်စွာ ဖြေရှင်းသည်။ ၎င်းသည် ပြင်ပသံလိုက်စက်ကွင်းတစ်ခုအား အသုံးပြုထားပြီး အိုင်းယွန်း၏မျဉ်းဖြောင့်လမ်းကြောင်းကို သံလိုက်စက်ကွင်းဦးတည်ချက်တစ်ဝိုက်ရှိ helical လမ်းကြောင်းအဖြစ် ပြောင်းလဲရန်၊ ၎င်းတို့၏လမ်းကြောင်းကို ရှည်လျားစေပြီး ပစ်မှတ်မော်လီကျူးများနှင့် တိုက်မိမှုစွမ်းရည်ကို မြှင့်တင်ပေးကာ sputtering efficiency ကို မြှင့်တင်ပေးပါသည်။ ယင်းသည် စုဆောင်းမှုနှုန်း တိုးလာခြင်း၊ အလုပ်ဖိအားများ လျော့ကျလာပြီး ရုပ်ရှင်အရည်အသွေး သိသိသာသာ တိုးတက်လာစေသည်။
4. Etching နည်းပညာများ
Etching ကို ခြောက်သွေ့သော နှင့် စိုစွတ်သော ပုံစံများဖြင့် ခွဲခြားသတ်မှတ်ထားပြီး ၎င်းတို့၏ အသုံးပြုမှု (သို့မဟုတ်) တိကျသော ဖြေရှင်းနည်းများ မရှိခြင်းအတွက် အသီးသီး အမည်ပေးထားသည်။
ပုံမှန်အားဖြင့်၊ etching သည် etching အတွက် ရည်ရွယ်ခြင်းမရှိသော နေရာများကို ကာကွယ်ရန်အတွက် mask layer (တိုက်ရိုက် photoresist လုပ်နိုင်သည်) ပြင်ဆင်မှု လိုအပ်ပါသည်။
(၁) အခြောက်ခံခြင်း
အသုံးများတဲ့ dry etching အမျိုးအစားတွေ ပါဝင်ပါတယ်။Inductively Coupled Plasma (ICP) etching၊ Ion Beam Etching (IBE) နှင့် Reactive Ion Etching (RIE)။
ICP etching တွင်၊ glow discharge-produced plasma တွင် ဓာတုဗေဒအရ တက်ကြွသော ဖရီးရယ်ဒီကယ် (free atoms, molecules, or atomic group) မြောက်မြားစွာပါ၀င်ပြီး မငြိမ်မသက်ဖြစ်စေသော ထုတ်ကုန်များဖြစ်လာစေရန် ပစ်မှတ်ပစ္စည်းနှင့် ဓာတုဗေဒအရ တုံ့ပြန်သောကြောင့် etching ကိုရရှိနိုင်ပါသည်။
IBE သည် ရုပ်ပိုင်းဆိုင်ရာ လုပ်ငန်းစဉ်ကို ကိုယ်စားပြုသည့် ပစ်မှတ်ပစ္စည်း၏ မျက်နှာပြင်ကို တိုက်ရိုက် ဗုံးကြဲရန်အတွက် စွမ်းအင်မြင့် အိုင်းယွန်း (အင်မတန်ဓာတ်ငွေ့များမှ အိုင်းယွန်း) ကို အသုံးပြုထားသည်။
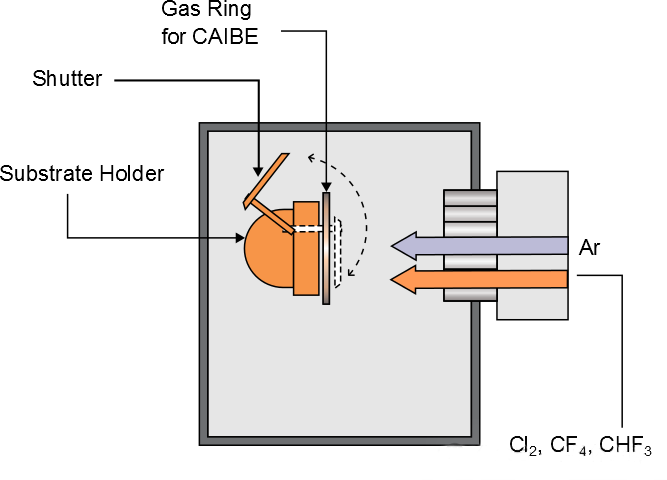
RIE သည် ယခင်နှစ်ခု၏ပေါင်းစပ်မှုဟုယူဆပြီး IBE တွင်အသုံးပြုသည့် inert gas ကို ICP etching တွင်အသုံးပြုသောဓာတ်ငွေ့ဖြင့်အစားထိုးကာ RIE ဖြင့်ဖွဲ့စည်းထားသည်။
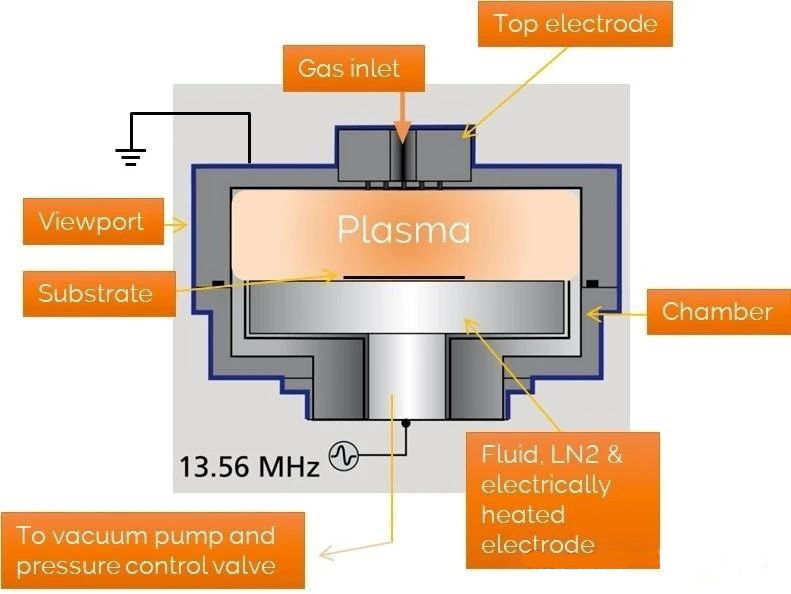
ခြောက်သွေ့သော ထွင်းထုခြင်းအတွက်၊ ဒေါင်လိုက် ထွင်းထုမှုနှုန်းသည် ဘေးထွက်နှုန်းထက် အဆပေါင်းများစွာ ကျော်လွန်နေသည်၊ ဆိုလိုသည်မှာ၊ ၎င်းသည် မျက်နှာဖုံးပုံစံ၏ တိကျသောပုံတူပွားမှုကို ခွင့်ပြုနိုင်သော မြင့်မားသောရှုထောင့်အချိုးရှိသည်။ သို့သော်၊ ခြောက်သွေ့သော ထွင်းထုခြင်းသည် ညံ့ဖျင်းသော ရွေးချယ်နိုင်စွမ်းကို ပြသခြင်း (မျက်နှာဖုံးအလွှာသို့ ပစ်မှတ်ပစ္စည်း၏ ထွင်းထုမှုနှုန်း အချိုးအစား)၊ အထူးသဖြင့် IBE နှင့်၊ အထူးသဖြင့် ပစ္စည်း၏ မျက်နှာပြင်တစ်လျှောက်တွင် မရွေးဘဲ ထွင်းထုနိုင်သည်ကို ပြသသော မျက်နှာဖုံးအလွှာကိုလည်း ထွင်းထုပါသည်။
(၂) ရေစိုခံခြင်း။
Wet etching သည် ၎င်းနှင့် ဓာတုဗေဒအရ ဓာတ်ပြုသည့် အဖြေ (etchant) တွင် ပစ်မှတ်ပစ္စည်းကို နှစ်မြှုပ်ခြင်းဖြင့် အောင်မြင်သည့် etching နည်းလမ်းကို ရည်ညွှန်းသည်။
ဤထွင်းထုနည်းသည် ရိုးရှင်းပြီး ကုန်ကျစရိတ်သက်သာပြီး ကောင်းသောရွေးချယ်မှုကိုပြသသော်လည်း အချိုးအစားနည်းပါးသည်။ မျက်နှာဖုံးအစွန်းများအောက်ရှိ ပစ္စည်းသည် ပုပ်သွားနိုင်ပြီး ခြောက်သွေ့သော ခြစ်ခြင်းထက် တိကျမှုနည်းသည်။ နိမ့်သောအချိုးအစား၏ အနုတ်လက္ခဏာသက်ရောက်မှုများကို လျော့ပါးစေရန်၊ သင့်လျော်သော ထွင်းထုနှုန်းများကို ရွေးချယ်ရပါမည်။ etching rate ကို လွှမ်းမိုးသည့် အချက်များ တွင် etchant concentration၊ etching time နှင့် etchant temperature တို့ ပါဝင်သည်။**




