
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
LPCVD လုပ်ငန်းစဉ်များသည် အဘယ်နည်း။
Low Pressure chemical vapor deposition (LPCVD) လုပ်ငန်းစဉ်များသည် ဖိအားနည်းသော ပတ်ဝန်းကျင်အောက်တွင် wafer မျက်နှာပြင်များပေါ်တွင် ပါးလွှာသော ဖလင်ပစ္စည်းများကို CVD ဖြင့် အပ်နှံသည့် နည်းစနစ်များဖြစ်သည်။ LPCVD လုပ်ငန်းစဉ်များကို တစ်ပိုင်းလျှပ်ကူးပစ္စည်းထုတ်လုပ်ခြင်း၊ optoelectronics နှင့် ပါးလွှာသော ဆိုလာဆဲလ်များအတွက် ပစ္စည်းအပ်နှံခြင်းနည်းပညာများတွင် တွင်ကျယ်စွာအသုံးပြုပါသည်။
LPCVD ၏ တုံ့ပြန်မှု လုပ်ငန်းစဉ်များကို ပုံမှန်အားဖြင့် ဖိအား 1-10 Torr ဖြင့် ဖိအားနည်းသော တုံ့ပြန်ခန်းတွင် လုပ်ဆောင်သည်။ wafer သည် deposition တုံ့ပြန်မှုအတွက်သင့်လျော်သောအပူချိန်အကွာအဝေးသို့အပူပေးပြီးနောက်၊ gaseous precursors များကို deposition အတွက်တုံ့ပြန်မှုခန်းထဲသို့ထည့်သွင်းသည်။ ဓာတ်ပြုသောဓာတ်ငွေ့များသည် wafer မျက်နှာပြင်သို့ ပျံ့နှံ့သွားပြီး မြင့်မားသောအပူချိန်အခြေအနေတွင် wafer မျက်နှာပြင်ပေါ်ရှိ ဓာတုဗေဒတုံ့ပြန်မှုများသည် အစိုင်အခဲအနည်ငယ်များ (ပါးလွှာသောရုပ်ရှင်များ) ဖြစ်ပေါ်လာသည်။
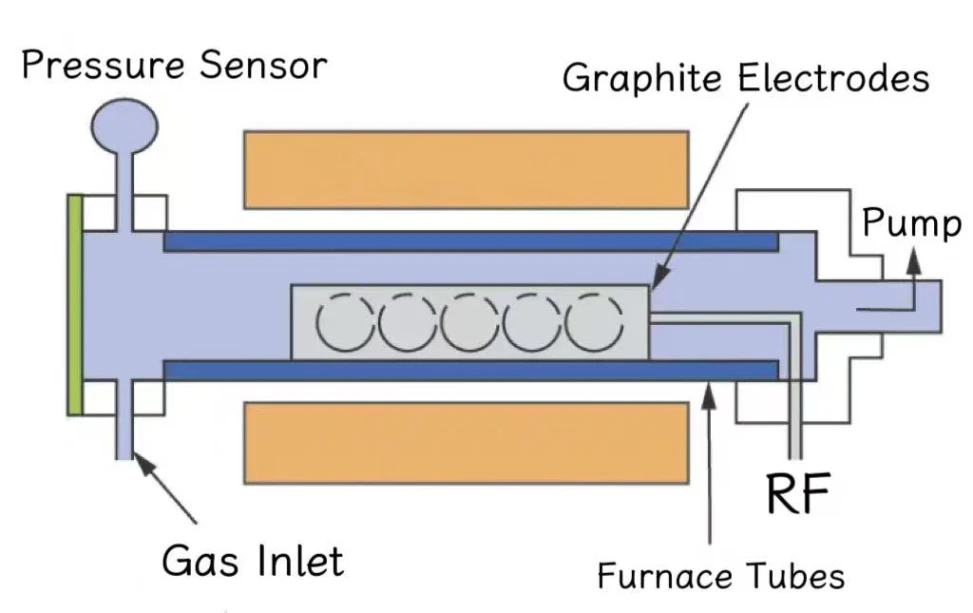
LPCVD လုပ်ငန်းစဉ်များ၏ အားသာချက်များ
1.High-quality ပါးလွှာသောရုပ်ရှင်အစစ်ခံအရည်အသွေး
ဓာတ်ငွေ့များ၏ ပျံ့နှံ့မှုကိန်းဂဏန်းများ တိုးလာသောကြောင့် ဖိအားနည်းသောအခါ ဓာတ်ပြုဓာတ်ငွေ့များ၏ သယ်ယူပို့ဆောင်မှုနှုန်းကို မြန်ဆန်စေသည်။ ထို့ကြောင့်၊ ဓာတ်ငွေ့မော်လီကျူးများသည် wafer မျက်နှာပြင်နှင့် အပြည့်အဝတုံ့ပြန်မှုကို သေချာစေပြီး မပြည့်စုံသောတုံ့ပြန်မှုများကြောင့် ဖြစ်ပေါ်လာသော အပျက်အစီးများ သို့မဟုတ် အထူကွာခြားမှုများကို သိသိသာသာ လျှော့ချပေးသည့် ဓာတ်ငွေ့မော်လီကျူးများကို တစ်ပြေးညီခွဲဝေသည့် အခန်းတစ်လျှောက် ဖန်တီးနိုင်မည်ဖြစ်သည်။
2. ဒီဇာတ်ကားက အဆင့်တစ်ဆင့် လွှမ်းခြုံမှု အရမ်းကောင်းပါတယ်။
လေဖိအားနည်းရပ်ဝန်းအောက်တွင် ပိုမိုကောင်းမွန်သော ဓာတ်ငွေ့ပျံ့နှံ့နိုင်မှုစွမ်းရည်သည် ရှုပ်ထွေးသောဖွဲ့စည်းပုံများအတွင်းသို့ နက်ရှိုင်းစွာ ထိုးဖောက်ဝင်ရောက်နိုင်စေပါသည်။ ၎င်းသည် ဓာတ်ပြုဓာတ်ငွေ့သည် wafer မျက်နှာပြင်ပေါ်ရှိ ခြေလှမ်းများနှင့် ကတုတ်ကျင်းများနှင့် အပြည့်အ၀ ထိတွေ့နိုင်ပြီး ပါးလွှာသော ရုပ်ရှင်များ၏ တူညီသော အစစ်ခံမှုကို ရရှိစေပါသည်။ ရလဒ်အနေဖြင့်၊ အနုစိတ်ဖွဲ့စည်းပုံများပေါ်တွင် ပါးလွှာသောဖလင်များကို စုဆောင်းခြင်းသည် LPCVD နည်းလမ်းအတွက် ကောင်းမွန်သောအသုံးချမှုတစ်ခုဖြစ်သည်။
3. ခိုင်မာသောလည်ပတ်ထိန်းချုပ်နိုင်မှု
LPCVD လုပ်ငန်းစဉ်များသည် အမှန်တကယ်လည်ပတ်နေစဉ်အတွင်း ပြင်းထန်သော ထိန်းချုပ်နိုင်စွမ်းကို ပြသသည်။ အမျိုးအစား၊ စီးဆင်းမှုနှုန်း၊ အပူချိန်နှင့် ဖိအားများကဲ့သို့ ဓာတ်ပြုနိုင်သောဓာတ်ငွေ့ ဘောင်များကို ချိန်ညှိခြင်းဖြင့် ပါးလွှာသော ဖလင်၏ဖွဲ့စည်းပုံ၊ ဖွဲ့စည်းပုံနှင့် အထူတို့ကို တိကျစွာ ထိန်းချုပ်နိုင်သည်။ LPCVD စက်ပစ္စည်းများသည် အခြားသော အပ်နှံနည်းပညာများနှင့် နှိုင်းယှဉ်လျှင် ရင်းနှီးမြှုပ်နှံမှုနှင့် လည်ပတ်မှုစရိတ်အတော်လေးနည်းပါးပြီး ၎င်းသည် အကြီးစားစက်မှုလုပ်ငန်းထုတ်လုပ်မှုအတွက် သင့်လျော်သည်။ ထို့အပြင် အစုလိုက်အပြုံလိုက် ထုတ်လုပ်မှုအတွင်း လုပ်ငန်းစဉ်များတွင် ညီညွတ်မှုကို အချိန်နှင့်တပြေးညီ စောင့်ကြည့်ထိန်းညှိပေးသည့် အလိုအလျောက် အလိုအလျောက်စနစ်များဖြင့် ထိရောက်စွာ အာမခံနိုင်မည်ဖြစ်သည်။
LPCVD လုပ်ငန်းစဉ်များ၏ အားနည်းချက်များ
LPCVD လုပ်ငန်းစဉ်များကို ပုံမှန်အားဖြင့် မြင့်မားသောအပူချိန်တွင် လုပ်ဆောင်ကြပြီး အချို့သော အပူချိန်-ထိခိုက်လွယ်သော ပစ္စည်းများကို အသုံးချခြင်းကို ကန့်သတ်ထားသောကြောင့်၊ LPCVD ဖြင့် လုပ်ဆောင်ရန် လိုအပ်သော wafer များသည် အပူခံနိုင်ရည်ရှိရပါမည်။ LPCVD လုပ်ငန်းစဉ်များအတွင်း၊ မလိုလားအပ်သောပြဿနာများဖြစ်သည့် wafer wrap-deposion (wafer ၏ပစ်မှတ်မဟုတ်သောနေရာများတွင် တင်ထားသော ပါးလွှာသောရုပ်ရှင်များ) နှင့် ဖြေရှင်းရန် နောက်ဆက်တွဲလုပ်ဆောင်ရန် လိုအပ်သည့် in-site doping ပြဿနာများ ဖြစ်ပေါ်လာနိုင်သည်။ ထို့အပြင်၊ ဖိအားနည်းသောအခြေအနေများအောက်တွင် အခိုးအငွေ့ရှေ့ပြေးပရိုဆက်ဆာများ၏ အာရုံစူးစိုက်မှုနည်းပါးခြင်းသည် ပါးလွှာသောဖလင်များ စုဆောင်းမှုနှုန်းကို လျော့နည်းသွားစေပြီး ထိရောက်မှုမရှိဘဲ ထုတ်လုပ်မှုထိရောက်မှုကို ဖြစ်ပေါ်စေပါသည်။
Semicorex သည် အရည်အသွေးမြင့်မှုကို ပေးသည်။SiC furnace ပြွန်s, SiC cantilever paddlesနှင့်SiC wafer လှေများLPCVD လုပ်ငန်းစဉ်များအတွက်။ သင့်တွင် စုံစမ်းမေးမြန်းမှုများ သို့မဟုတ် နောက်ထပ်အသေးစိတ်အချက်အလက်များ လိုအပ်ပါက၊ ကျွန်ုပ်တို့ထံ ဆက်သွယ်ရန် တုံ့ဆိုင်းမနေပါနှင့်။
ဖုန်း # +86-13567891907 သို့ ဆက်သွယ်နိုင်ပါသည်။
အီးမေးလ်- sales@semicorex.com





